我们深知化学镀镍浸金(ENIG)表面处理工艺在当今电子制造业中的重要地位。其优良的可焊性、良好的平整度以及适合无铅工艺的特性,使其成为PCB表面处理的主流选择之一。然而,ENIG工艺也存在着一个致命的弱点——黑垫(Black Pad)现象。本文将从PCB厂家的角度,深入分析ENIG黑垫的成因、识别方法以及对产品可靠性的影响,帮助客户更好地理解这一现象并采取有效预防措施。
ENIG黑垫的形成机理
ENIG黑垫的形成是一个复杂的化学过程,主要源于化镍浸金处理过程中的工艺控制不当。从PCB厂家的生产经验来看,黑垫现象主要由以下几方面因素导致:
首先,化学镀镍过程中磷含量控制不当是主要原因之一。研究表明,镍层中磷的正常比例应保持在7%-10%之间。当磷含量偏低时(低于7%),镀层耐腐蚀性会大大降低,容易受到酸性金水的侵蚀;而当磷含量偏高时(高于10%),虽然耐腐蚀性增强,但会导致镀层硬度增加,可焊性下降
其次,浸金过程中的过度反应也是造成黑垫的重要原因。在浸金过程中,金通过化学置换反应沉积到镍层表面,而部分表面的镍则溶入金水中。如果反应过度,会导致镍层受到过度侵蚀,形成氧化镍(NixOy)同时,由于金原子半径(144pm)较大,不规则沉积会形成粗糙且疏松多孔的晶粒排列,使金层无法完全覆盖镍层,让镍层有机会暴露于空气中继续氧化。
第三,工艺参数控制不当也会加剧黑垫的形成。这包括镍槽液温度、pH值、金槽温度、浸泡时间等参数的控制。特别是在夏季高温高湿环境下(6-9月),黑垫问题更容易出现,这可能与环境温湿度对化学反应的影响有关
ENIG黑垫的识别与检测方法
作为PCB厂家,我们建议采用多种方法结合来识别和检测ENIG黑垫问题:
1.
外观检查:虽然黑垫问题通常无法通过肉眼直接识别(因为表面金层看起来仍然完好),但使用光学显微镜(250X)观察可以发现焊盘拒焊及反湿润现象。过炉后金层依然存在,没有形成完整的焊点
2.
切片分析:通过金相切片技术可以清晰观察到镍层状况。黑垫的典型特征是存在纵向腐蚀性裂纹,镍层表面被氧化,且金层与镍层之间存在分离现象
3.
SEM&EDS分析:使用扫描电子显微镜(SEM)观察焊盘表面微观结构,配合能谱分析仪(EDS)分析元素组成,可以检测到镍元素异常扩散到金层中,以及磷含量异常情况
4.
可焊性测试:参考IPC-J-STD-033测试方法,对刚拆包装的PCB板焊盘进行可焊性测试。黑垫板通常无法通过可焊性测试,即使延长手工加锡时间和提高焊接温度(如8S时间,410度烙铁温度)也无法使焊盘湿润铺展
5.
推拉强度测试:对典型焊垫进行手工焊接并测量焊点的推拉强度,黑垫存在的焊点推拉强度会明显异常偏小。
ENIG黑垫对产品可靠性的影响
ENIG黑垫对电子产品的可靠性有着严重的影响:
1.
焊接强度降低:黑垫会导致焊料无法与镍层形成良好的IMC(金属间化合物)合金层,即使勉强形成,其IMC也是断断续续不均匀,造成焊接强度大幅降低
2.
长期可靠性问题:存在黑垫的焊点在后续使用过程中,会受到热疲劳、机械应力等影响,容易出现开裂失效,导致电路功能中断
3.
产品失效隐蔽性:黑垫问题在生产当下往往不易被察觉,一旦发现通常为时已晚,可能已经造成批量性质量事故,带来巨大的经济损失
4.
返修难度大:存在黑垫的板子返修难度极大,常规加锡处理无法解决焊盘润湿问题,往往需要采用非常规返工方法,甚至可能导致产品报废
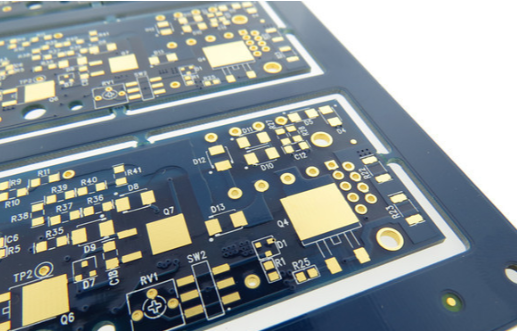
作为PCB厂家,我们深刻认识到ENIG黑垫问题的严重性和复杂性。通过深入分析其成因、识别方法及影响,我们可以更好地优化生产工艺,减少黑垫问题的发生。同时,我们也建议客户在选择ENIG表面处理时,要综合考虑产品应用领域和可靠性要求,对于高可靠性产品,可以考虑采用ENEPIG等更先进的表面处理工艺。





















 366
366

 被折叠的 条评论
为什么被折叠?
被折叠的 条评论
为什么被折叠?








