通孔回流焊(THR)工艺正在替代传统波峰焊。这种工艺能让通孔插件元件(如连接器、端子)和贴片元件一起完成焊接。这简化了生产流程。
但工程师在实际操作中面临一个核心矛盾:通孔元件必须承受回流焊的高温环境,而许多传统插件元件的材料却无法适应这种温度冲击。这种冲突是当前可制造性设计(DFM)需要解决的关键问题。
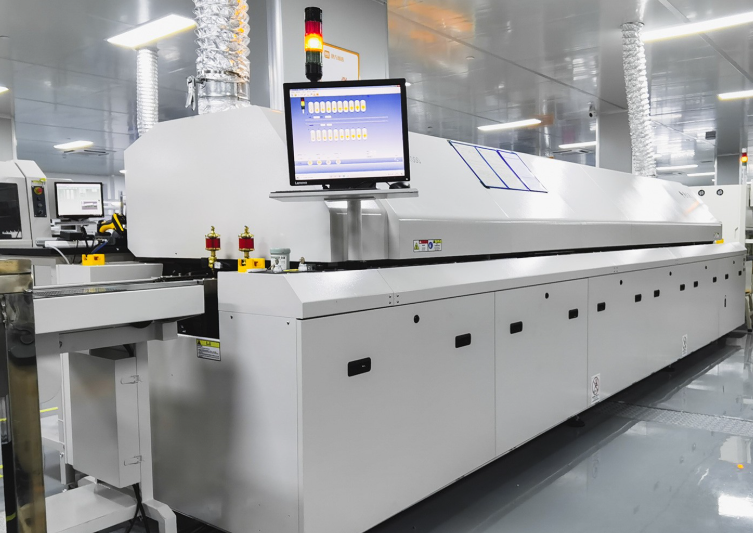
元件耐热性:
通孔元件在回流焊中要经历整个温度曲线。无铅工艺的峰值温度通常达到240–260℃,时间持续60–90秒。但许多传统插件元件(如铝电解电容、塑封连接器)的耐温上限仅为220℃。一旦超过这个温度,元件本体容易发生熔损、变形或分层。
例如,某企业在升级电源模块时发现,普通排针的塑料基座在高温下软化,导致引脚倾斜形成桥连。后来他们只能更换为聚亚苯基硫化物(PPS)或液晶聚合物(LCP) 材质的耐高温插件。
元件设计也需配合高温环境。元件底部需设置0.3–0.5mm的“立高销”,避免本体直接接触熔融锡膏。引脚长度也要控制在≤1.27mm,否则多余焊料会形成锡珠。
锡膏与钢网如何平衡?
通孔回流焊的锡膏用量是贴片元件的2–3倍。因为锡膏不仅要填充通孔,还需形成双面焊点。但过量锡膏会带来新问题:
-
助焊剂挥发物沉积在炉膛内,污染设备;
-
元件压塌锡膏后形成溅射锡珠。
我们常采用阶梯钢网来解决这一矛盾。例如,在IC或连接器位置将钢网局部加厚0.05–0.1mm,增加锡膏量。但钢网开孔需避开元件本体,否则贴装时锡膏会被挤压飞溅。某通信模块案例中,通过将钢网开孔从矩形改为哑铃形,锡珠率从15%降至2%以下。

温度控制
回流温度曲线是THR工艺的成败关键。工程师需要同时满足三个条件:
-
预热区升温速率≤3℃/秒,防止元件热应力开裂;
-
回流区峰值温度240–245℃,维持60–90秒,确保通孔透锡率>75%;
-
冷却速率≤4℃/秒,避免焊点晶粒粗化而强度下降。
实际操作中,对于混合了BGA和通孔元件的板卡,需在炉膛内设置多温区独立调控。高密度区域需降低风速,而大尺寸插件区则需提升热风流量。
DFM优化:从设计端预防冲突
要真正解决这一冲突,需在设计阶段就介入:
-
元件布局:将热敏感元件(如电解电容)远离高温回流区,高元件(>25mm)避免靠近板边以防撞炉;
-
焊盘设计:通孔直径比引脚大0.3–0.5mm,给锡膏流动留出空间;
-
仿真先行:用三维电磁热仿真软件预测温度分布,识别潜在过热点。
某继电器生产商在导入THR工艺时发现,通过X光检测通孔填充率可提前发现空洞缺陷。调整预热时间后,透锡合格率从70%提升到98%。
通孔回流焊的推广本质上是对电子制造效率的革新。但它的实现需要DFM理念的全流程协同——从元件的耐热选型、钢网的精准开孔,到炉温的分区调控。只有将这些环节串联成闭环,才能让通孔插件真正“融入”回流焊体系,在提升效率的同时保障可靠性。
 通孔回流焊工艺的可制造性冲突与解决
通孔回流焊工艺的可制造性冲突与解决






















 180
180

 被折叠的 条评论
为什么被折叠?
被折叠的 条评论
为什么被折叠?








