书籍:《炬丰科技-半导体工艺》
文章:晶片处理和清洗
编号:JFKJ-21-251
作者:炬丰科技
术语
晶圆
半导体的完整圆盘,通常从生长的晶锭上切割下来。
薄片
通过劈开而减小尺寸的晶片的一部分,例如仍然可以进行一些处理的半片、四分之一片或小矩形片。
模具
构成器件或集成电路的半导体部分的晶片或薄片的单个部分。在所有的晶片或切片处理完成之前,芯片通常不会被分离。它们通常太小,无法单独处理。
标准晶圆特征
表面
-
- 顶部:研磨、研磨和抛光。
- 底部:通常只是地面;看起来像是暗淡或无光泽的表面。
- 用于标记晶体取向。
晶片结晶取向
标记(011)平面的主平面索引:
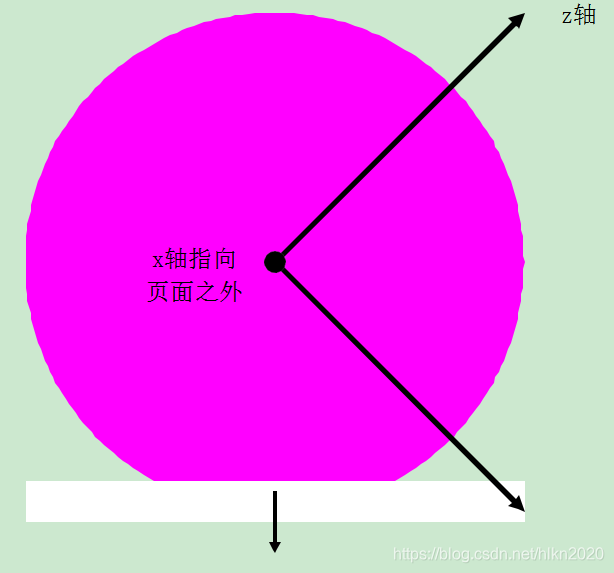
标准的硅晶片
- 最小厚度是标准加工通常需要的厚度。
- 重量是单个晶片在这个厚度下的重量。

晶片存储容器
- 晶片
- 用来装一个晶片。
- 由底部托盘、弹簧和盖子组成,用于将晶圆固定到位。
- 切片
- 用来装几片晶片的分隔托盘。
- 包括一个底部、一个顶部和一个保持其闭合的外部弹簧。
- 模具
- 分隔托盘,用于容纳晶片或切片的多个芯片。
- 包括一个底部、一个顶部和一个保持其闭合的外部弹簧。
晶圆托盘组装
- 标准氟塑料设计–聚丙烯材料。
- 适用于1、2、3英寸;100、125、150毫米晶圆。
- 托盘和弹簧应该只接触晶片的边缘。
- 装载前可以并且应该用溶剂清洗。
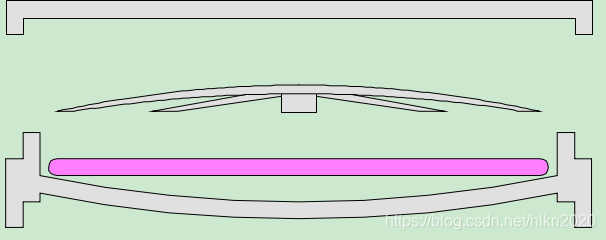
晶片传送
- 晶圆从不直接用手处理。
- 在加工过程中,只有晶圆钳或真空棒接触晶圆。
- 晶圆钳:
- 有一个锋利的铲子、铲子或刀片末端,可以在晶圆的圆形边缘下方滑动。
- 用钝的钳子或将晶片夹在刀片上。
- 对切片或方形边缘的模具无效。
- 根据晶圆直径确定尺寸(最大6英寸晶圆)




 本文详细介绍了半导体制造中的晶圆处理和清洗过程,涵盖了晶圆的定义、晶圆的切割、芯片制造、标准晶圆特征、存储容器以及处理和传送工具。内容涉及晶圆的表面处理、结晶取向、标准尺寸和重量,以及在加工中如何避免直接接触以防止污染。
本文详细介绍了半导体制造中的晶圆处理和清洗过程,涵盖了晶圆的定义、晶圆的切割、芯片制造、标准晶圆特征、存储容器以及处理和传送工具。内容涉及晶圆的表面处理、结晶取向、标准尺寸和重量,以及在加工中如何避免直接接触以防止污染。
















 708
708

 被折叠的 条评论
为什么被折叠?
被折叠的 条评论
为什么被折叠?








