💥💥💞💞欢迎来到本博客❤️❤️💥💥
🏆博主优势:🌞🌞🌞博客内容尽量做到思维缜密,逻辑清晰,为了方便读者。
⛳️座右铭:行百里者,半于九十。
📋📋📋本文内容如下:🎁🎁🎁
⛳️赠与读者
👨💻做科研,涉及到一个深在的思想系统,需要科研者逻辑缜密,踏实认真,但是不能只是努力,很多时候借力比努力更重要,然后还要有仰望星空的创新点和启发点。建议读者按目录次序逐一浏览,免得骤然跌入幽暗的迷宫找不到来时的路,它不足为你揭示全部问题的答案,但若能解答你胸中升起的一朵朵疑云,也未尝不会酿成晚霞斑斓的别一番景致,万一它给你带来了一场精神世界的苦雨,那就借机洗刷一下原来存放在那儿的“躺平”上的尘埃吧。
或许,雨过云收,神驰的天地更清朗.......🔎🔎🔎
💥1 题目概述
碳化硅作为一种新兴的第三代半导体材料,以其优越的综合性能表现正在受到越来越多
的关注。碳化硅外延层的厚度是外延材料的关键参数之一,对器件性能有重要影响。因此,
制定一套科学、准确、可靠的碳化硅外延层厚度测试标准显得尤为重要。
红外干涉法是外延层厚度测量的无损伤测量方法,其工作原理是,外延层与衬底因掺杂
载流子浓度的不同而有不同的折射率,红外光入射到外延层后,一部分从外延层表面反射出
来,另一部分从衬底表面反射回来(图 1),这两束光在一定条件下会产生干涉条纹。可根据
红外光谱的波长、外延层的折射率和红外光的入射角等参数确定外延层的厚度。
通常外延层的折射率不是常数,它与掺杂载流子的浓度、红外光谱的波长等参数有关。
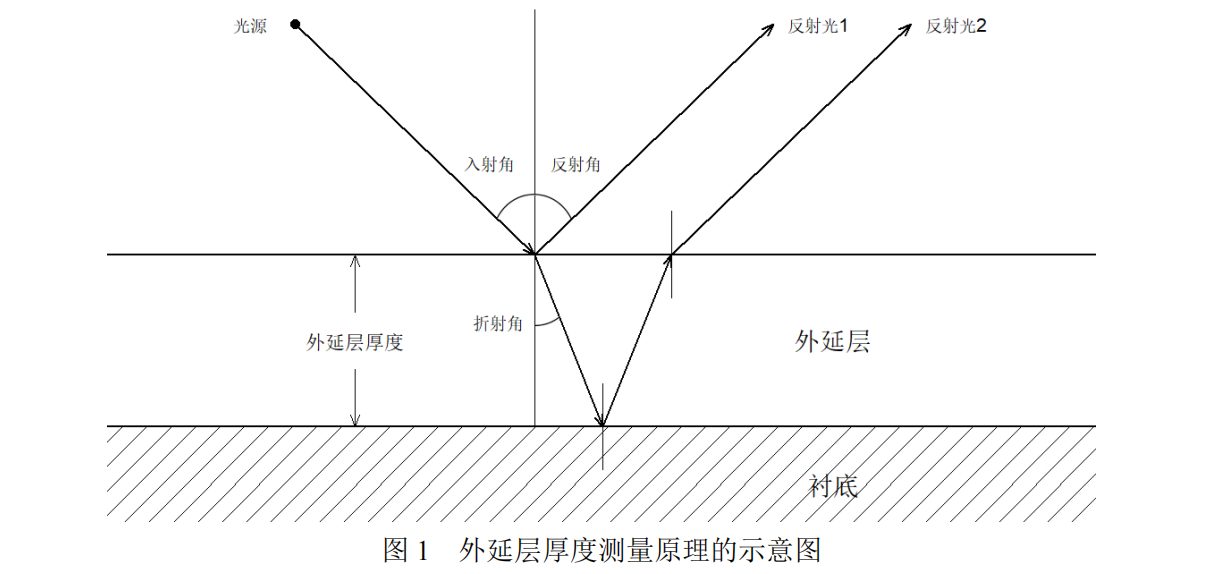
问题 1 如果考虑外延层和衬底界面只有一次反射、透射所产生的干涉条纹的情形(图
1),建立确定外延层厚度的数学模型。
问题 2 请根据问题 1 的数学模型,设计确定外延层厚度的算法。对附件 1 和附件 2 提
供的碳化硅晶圆片的光谱实测数据,给出计算结果,并分析结果的可靠性。
问题 3 光波可以在外延层界面和衬底界面产生多次反射和透射(图 2),从而产生多光
束干涉。请推导产生多光束干涉的必要条件,以及多光束干涉对外延层厚度计算精度可能产
生的影响。
请根据多光束干涉的必要条件,分析附件 3 和附件 4 提供的硅晶圆片的测试结果是否
出现多光束干涉,给出确定硅外延层厚度计算的数学模型和算法,以及相应的计算结果。
如果你们认为,多光束干涉也会出现在碳化硅晶圆片的测试结果(附件 1 和附件 2)中,
从而影响到碳化硅外延层厚度计算的精度,请设法消除其影响,并给出消除影响后的计算结
果。

附件说明
(1) 附件 1.xlsx 和附件 2.xlsx 是入射角分别为 10° 和 15° 时针对同一块碳化硅晶圆片
的测试结果,其中第 1 列为波数(单位:cm−1),第 2 列为干涉光谱的反射率(单位:%)。
(2) 附件 3.xlsx 和附件 4.xlsx 是入射角分别为 10° 和 15° 时针对同一块硅晶圆片的测
试结果,其中第 1 列为波数(单位:cm−1),第 2 列为干涉光谱的反射率(单位:%)。
完整题目及数据第4部分下载
💥2 论文摘要
本研究以红外干涉法原理为依托,深入且系统地探究了碳化硅与硅外延层厚度的无损测量技术。构建了涵盖从单次反射干涉到多光束干涉的完整数学模型体系,并据此设计开发了相应的计算算法,同时对实际测量数据展开了细致入微的分析。研究结果表明,精准把握干涉现象的本质以及合理选取模型,对于获取可靠的外延层厚度测量结果起着决定性作用。特别是在界面反射率处于较高水平时,多光束干涉效应会极大地影响测量精度。通过对比不同模型并验证方法,本研究为半导体外延层厚度的精确测定提供了坚实的科学依据与有力的技术支撑。
针对问题1,本研究依据光的干涉原理,构建了考虑单次反射情况的碳化硅外延层厚度测量数学模型。该模型从光在多层介质中的传播规律入手,深入剖析了当红外光射入外延层结构时,在空气 - 外延层界面以及外延层 - 衬底界面所产生的反射光之间的光程差与相位差。在此基础上,推导出相邻干涉极值点的波数差Δν和外延层厚度d之间的数学关系,即d = 1/(2Δν√(n₂² - sin²θ₀))。鉴于外延层折射率n₂与波长存在依赖关系,引入了Sellmeier色散模型n₂(ν) = n₀ + A/ν²,其中n₀取值为2.6,A取值为1000。此模型结构简洁、逻辑清晰,直接揭示了干涉条纹形成的物理本质,为后续算法的设计搭建了坚实的理论框架。
针对问题2,基于问题1所构建的数学模型,本研究设计了一套完整的算法流程,用于处理实际测量数据并计算碳化硅外延层厚度。该算法主要涵盖数据预处理、极值点检测、厚度计算以及统计分析四个关键环节。在极值点检测过程中,运用MATLAB的findpeaks函数来检测反射率曲线中的极大值和极小值点,并通过合理设置MinPeakProminence和MinPeakDistance参数,有效提升了检测的可靠性。在统计分析环节,采用Z分数方法识别并剔除异常厚度值,同时计算平均厚度、标准偏差、置信区间等统计量,以此评估测量结果的可靠性。分析结果显示,碳化硅外延层厚度为11.34 ± 3.84μm,两个入射角(10°和15°)测量结果的相对差异为6.22%,但变异系数高达47% - 49%,这表明测量结果的可靠性有待提高。通过绘制波数差与厚度关系图,验证了理论模型的正确性。同时,观察到在约900 cm⁻¹处存在碳化硅特征声子吸收峰,该吸收峰可能会对测量结果产生干扰。
针对问题3,本研究对多光束干涉现象及其对厚度测量的影响展开了深入探究。通过理论分析,推导出产生多光束干涉的必要条件,即界面反射率需足够高,且多次反射光波能够保持良好的相干性。在此基础上,建立了基于艾里公式的多光束干涉模型,并设计了一套多光束干涉判断标准,该标准包括峰谷不对称性、峰谷对比度和精细度三个指标。运用这套标准进行分析发现,硅和碳化硅外延层测试数据均存在多光束干涉现象。对于硅外延层,考虑多光束干涉因素后计算得到的厚度为14.35 ± 8.66μm,相较于传统方法高出55.52%;对于碳化硅外延层,修正后的厚度为26.48 ± 1.48μm,比问题2的结果高出80.08%。研究还发现,艾里公式拟合法的计算结果约为11.47μm,优于极值点位置修正法的结果(约为41.48μm),且艾里公式拟合法与问题2的结果更为接近,这表明在处理碳化硅样品时,需要谨慎选择计算方法。
本研究的主要优势在于构建了从简单干涉到复杂多光束干涉的完整理论体系,并通过实际数据验证了模型的有效性。尤其是对多光束干涉现象的定量判断和处理方法,为提高半导体外延层厚度测量精度开辟了新的途径。然而,本研究也存在一定的局限性。例如,在处理具有特殊光学特性(如碳化硅的声子吸收峰)的材料时,模型的适用性面临挑战。未来研究可考虑引入复折射率和吸收特性,进一步提升模型的普适性和准确性。总之,本研究为半导体材料厚度的精确测量提供了科学依据和实用工具,对半导体器件制造的质量控制具有重要的参考价值。
关键词:碳化硅外延层;红外干涉法;厚度测量;多光束干涉;艾里公式;菲涅耳反射;色散关系;声子吸收
📚3 运行结果图













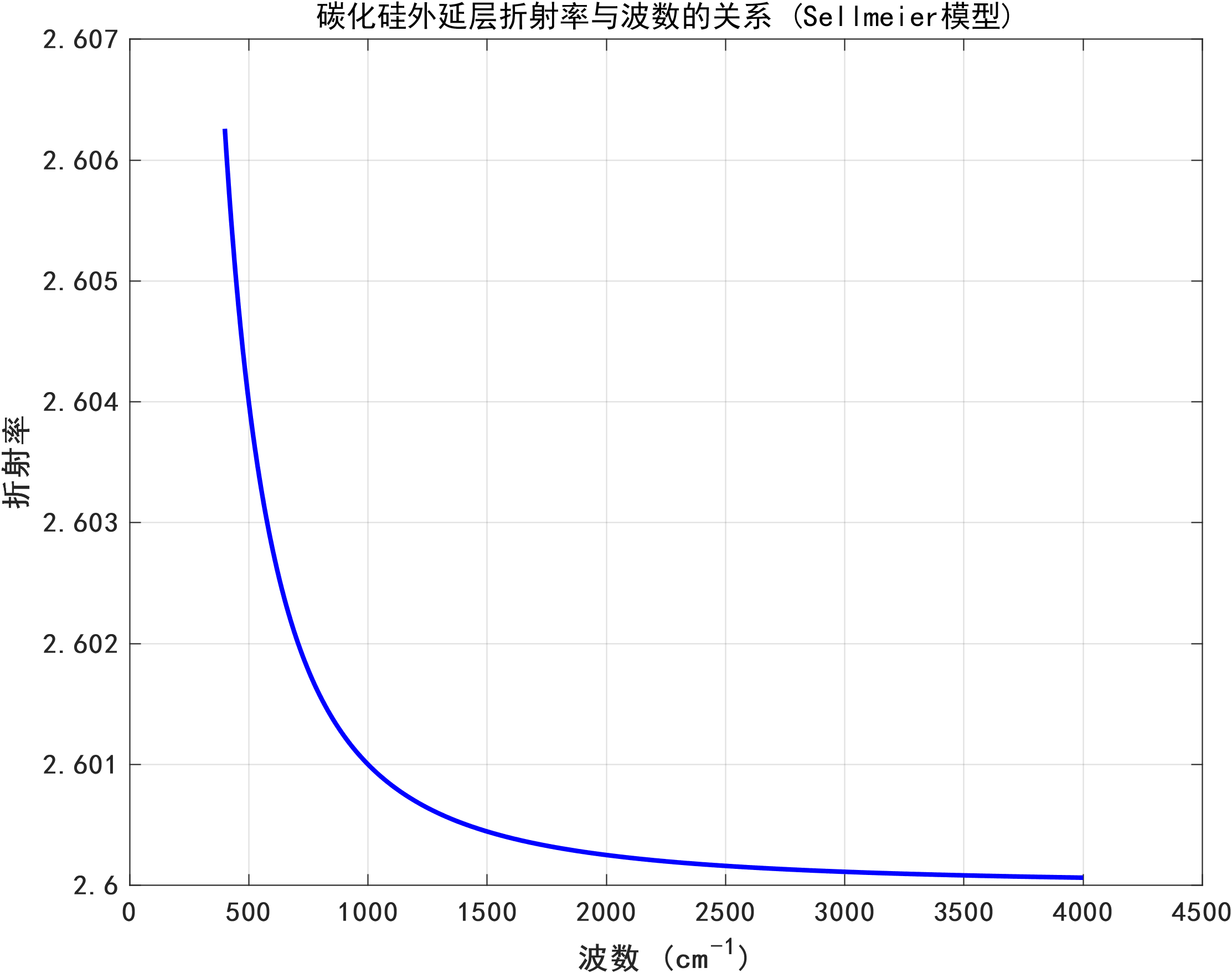
运行结果图比较多,就不一一展示。
🎉3 参考文献
文章中一些内容引自网络,会注明出处或引用为参考文献,难免有未尽之处,如有不妥,请随时联系删除。(文章内容仅供参考,具体效果以运行结果为准)
🌈4 Matlab代码、数据、文章下载
资料获取,更多粉丝福利,MATLAB|Simulink|Python资源获取





















 1168
1168

 被折叠的 条评论
为什么被折叠?
被折叠的 条评论
为什么被折叠?








