在高功率芯片封装中,铜基板表面的镀层就像 “连接桥梁”,既要保护铜面不被氧化,又要确保金线 / 铜线与基板的可靠连接。而镍钯金(ENEPIG)镀层凭借 “镍阻挡、钯过渡、金保护” 的三层结构,成为铜基板的 “黄金搭档”—— 尤其在需要打线键合的场景,其可靠性远超传统的镍金(ENIG)镀层。
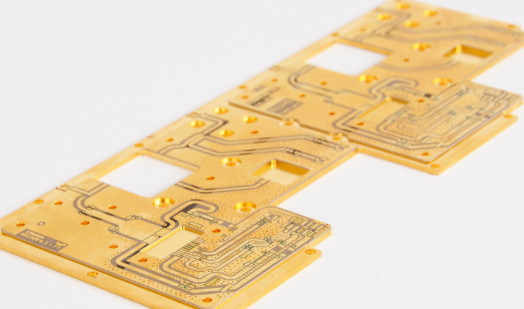
一、ENEPIG 的 “三层防护”:为什么比 ENIG 更适合铜基板?
ENEPIG(Electroless Nickel Electroless Palladium Immersion Gold)是在铜基板表面依次沉积化学镍、化学钯和浸金的三层镀层,每层都有不可替代的作用:
镍层(3-5μm) 是 “阻隔屏障”。铜的扩散能力极强(尤其在 150℃以上),会通过打线界面渗入键合区导致脆化。镍层能像 “防火墙” 一样阻止铜扩散,同时提供足够硬度(维氏硬度 200-300HV),确保打线时金线能形成稳定的球形焊点。
钯层(0.1-0.3μm) 是 “过渡桥梁”。它能防止镍层氧化(镍在空气中易形成氧化膜,导致打线虚接),同时与金线 / 铜线形成稳定的金属间化合物(如 Pd-Au、Pd-Cu)。相比 ENIG 工艺,钯层的存在让打线可靠性提升 30% 以上,尤其在湿热环境下表现更稳定。
金层(0.05-0.1μm) 是 “保护外衣”。超薄的金层能防止钯层氧化,同时降低打线时的接触电阻(金的电阻率仅 2.4μΩ・cm)。但金层并非越厚越好 —— 超过 0.1μm 会导致 “金脆” 现象,反而降低键合强度。
二、ENEPIG 完整流程:从铜面到镀层的 “五步修炼”
1. 前处理:让铜面 “干净又粗糙”
铜基板的前处理直接影响镀层结合力,步骤包括:
-
除油:用碱性清洗剂(pH 10-11)在 50℃下清洗 3-5 分钟,去除铜面的油污和指纹(油污会导致镀层局部脱落);
-
微蚀:用硫酸 - 双氧水体系(H₂SO₄ 100g/L + H₂O₂ 50g/L)蚀刻 1-2 分钟,去除铜面氧化层并形成均匀粗糙度(Ra 0.2-0.4μm)—— 粗糙度太低会导致镀层结合力不足,太高则易藏污纳垢;
-
活化:用 2% 盐酸浸泡 30 秒,中和残留的微蚀液,确保铜面呈活化状态。
2. 化学镀镍:控制磷含量是关键
在铜面沉积镍磷合金层,参数需严格控制:
-
温度:85-90℃(温度每降 5℃,沉积速率降 30%);
-
pH 值:4.5-5.0(酸性过强会腐蚀铜基板,过弱则镍层易产生针孔);
-
沉积时间:15-20 分钟(确保镍层厚度 3-5μm);
-
磷含量:8-10%(低磷镍硬度高但脆性大,高磷镍易腐蚀,8-10% 的中磷镍兼顾硬度与耐蚀性)。
镀镍后需用去离子水冲洗 3 次,避免残留液污染后续钯槽。
3. 化学镀钯:薄而均匀是核心
钯层厚度虽薄(0.1-0.3μm),但均匀性至关重要:
-
钯离子浓度:1-2g/L(浓度过高会导致钯层粗糙,过低则覆盖不均);
-
温度:60-65℃(低温下钯层沉积缓慢,高温则易产生钯颗粒);
-
pH 值:8-9(碱性环境能促进钯离子还原);
-
时间:3-5 分钟(根据目标厚度调整,每 1 分钟约沉积 0.05μm)。
钯层需连续覆盖镍层,任何针孔都会导致镍层氧化,进而影响打线 —— 某检测显示,钯层覆盖率<99.5% 时,打线不良率会飙升至 10% 以上。
4. 浸金:超薄且致密的 “最后防线”
浸金是利用置换反应在钯层表面形成金层:
-
金离子浓度:0.5-1g/L(过高会导致金层过厚,引发金脆);
-
温度:40-45℃(高温会加速钯层溶解,导致金层结合不良);
-
时间:30-60 秒(确保金层 0.05-0.1μm,刚好覆盖钯层即可);
-
后处理:用 1% 柠檬酸溶液中和 30 秒,去除残留金盐。
5. 烘干:避免 “隐性氧化”
-
采用热风烘干(60-80℃,5-10 分钟),避免高温长时间烘烤(会导致镍层氧化);
-
烘干后 24 小时内完成打线,暴露在空气中超过 48 小时会导致金层氧化,增加打线电阻。

三、打线可靠性的 “四大杀手” 及应对方案
1. 镍层氧化导致键合强度不足
现象:金线拉力值<6g,键合界面有黑色氧化斑。
原因:钯层厚度不足(<0.1μm)或存在针孔,导致镍层与空气接触氧化。
解决:钯层厚度控制在 0.15-0.2μm,镀钯后 2 小时内完成浸金,减少镍层暴露时间。
2. 金脆导致打线断裂
现象:金线在焊点根部断裂,断面呈脆性特征。
原因:金层过厚(>0.1μm),或打线温度过高(>220℃),导致金与钯过度反应形成脆性相。
解决:金层严格控制在 0.08μm 以下,打线温度降至 180-200℃,超声功率提高 10% 补偿温度降低的影响。
3. 镀层结合力差导致分层
现象:打线时镀层从铜基板表面脱落。
原因:前处理微蚀不足(Ra<0.2μm),或镀镍时 pH 值波动过大。
解决:微蚀后检查 Ra 值(确保 0.2-0.4μm),镀镍 pH 值控制在 ±0.1 范围内,每小时检测一次。
4. 湿热环境下接触电阻飙升
现象:85℃/85% RH 测试后,打线电阻增加超过 30%。
原因:钯层孔隙率高,水汽渗入后导致镍层腐蚀。
解决:镀钯时加入 0.1g/L 的有机添加剂(如联吡啶),降低钯层孔隙率至<0.1 个 /cm²。
四、不同打线材料的工艺匹配:金线 vs 铜线
1. 金线(直径 25-50μm):传统可靠之选
-
打线温度:180-200℃,压力 15-20gf,超声时间 20-30ms;
-
优势:与 ENEPIG 镀层兼容性好,键合强度稳定(拉力≥8g);
-
注意:避免金层过厚,防止金 - 钯金属间化合物过度生长(超过 0.5μm 会变脆)。
2. 铜线(直径 25-50μm):低成本高电流方案
-
打线温度:200-220℃(比金线高 20℃,确保铜与钯良好结合),压力 20-25gf,超声功率提高 20%;
-
优势:载流量比金线高 30%,成本降低 50%;
-
注意:铜线易氧化,需在氮气保护下打线(氧含量<50ppm),钯层厚度建议提高至 0.2-0.3μm 增强抗氧化能力。
ENEPIG 镀层为铜基板的打线可靠性提供了 “三重保障”,但工艺控制必须 “精打细算”:镍层的磷含量、钯层的均匀性、金层的厚度,每个参数都像 “多米诺骨牌”,一步出错就可能导致整体失效。对于工程师来说,需根据打线材料(金线 / 铜线)调整镀层参数,同时严控前处理和各镀层的沉积条件。随着功率芯片向高电流、小型化发展,ENEPIG 镀层与铜线的组合将成为主流,而掌握其工艺精髓,正是确保封装可靠性的关键。






















 236
236

 被折叠的 条评论
为什么被折叠?
被折叠的 条评论
为什么被折叠?








