书籍:《炬丰科技-半导体工艺》
文章:CMP清洗工艺中的颗粒粘附和去除机制
编号:JFKJ-21-382
作者:炬丰科技
摘要
化学机械抛光 (CMP) 被认为是一种范式转变,它使光学光刻继续下降到 0.12 m。目前,抛光物理还没有得到很好的定义,尽管众所周知,该工艺的性质使得 CMP 后的颗粒去除变得困难和必要。了解抛光过程产生的颗粒粘附机制以及粘附力对 CMP 后清洁过程中颗粒去除的影响非常重要。在本文中,强烈的颗粒粘附被证明是由在潮湿和长时间老化的情况下发生的化学反应(在初始氢键之后)引起的。在使用刷子清洁去除颗粒时,颗粒和刷子之间的接触对于去除亚微米颗粒至关重要。在非接触模式下,0。当刷子与颗粒的距离超过 1 maway 时,1-m 的颗粒几乎无法去除。在完全接触模式下,在研究的刷子旋转速度下可以去除 0.1 米的颗粒。实验数据表明,高刷压和短清洁时间可以实现高去除效率(低缺陷数量)。
简介
电路特征尺寸缩小,需要全局平面化技术是至关重要的。化学机械抛光 (CMP) 作为平坦化方法已被半导体行业广泛接受。CMP 工艺的基本要素包括一个旋转的晶片,该晶片面朝下压在浸有抛光浆的旋转抛光垫上。通常,垫和晶片载具都以相同的角速度在相同的方向上旋转。抛光浆由分散在含有化学试剂的水性介质中的胶体磨粒组成。抛光是研磨剂的机械作用和浆料中化学试剂的化学作用共同作用的结果。晶片中与抛光垫接触的高特征承受高压,因此比不与抛光垫接触的低特征抛光速度更快(直接化学蚀刻速率最小) ,导致全局平面化。
附着力
了解颗粒附着力对于在 CMP 后清洁过程中有效去除颗粒至关重要。晶片和颗粒之间的颗粒粘附发生如下:首先,长距离引力将颗粒拉向表面,直到污染物颗粒和晶片在一个接触点接触。然后,短程吸引力(范德华)在表面附近占主导地位,接触面积增加。由于粘附引起的变形,也可能发生变形,从而增加粘附力。最后变形停止,系统达到平衡。
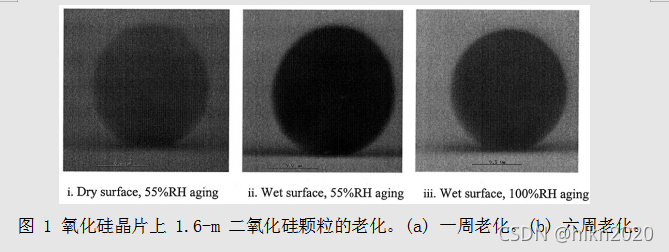

发现二氧化硅颗粒(在热氧化物晶片上)接触面积随着老化时间和水分的增加而增加。老化时间越长,水分含量越高,粘合力越大。此外,当液体存在于颗粒和基材之间时,它会引起二氧化硅颗粒和氧化硅基材之间的化学反应,从而形成共价键。由共价键引起的粘附力通常比范德华力大两个数量级。这使得从氧化硅晶片上去除二氧化硅颗粒极其困难(如果不是令人望而却步的话),如果留在晶片上老化的话。因此,目前大多数 CMP 后清洁单元都与 CMP 单元集成在一起。
去除机制
当液体流过基材时,亚微米颗粒从表面脱离时存在三种可能性:颗粒可能滑动、滚动或被提升。在刷子清洁中,滑动、提升和滚动是可能的去除机制。

结论
对于硬质基材上的软颗粒,附着力会随时间增加,反之亦然。颗粒上的外部载荷会增加变形,从而增加粘附力。在潮湿和长时间老化的情况下发生的化学反应(在最初的氢键之后)可能会导致强烈的颗粒粘附。在刷子清洁中,颗粒和刷子之间的接触对于去除亚微米颗粒至关重要。在非接触模式下,当刷子与颗粒的距离超过 1m 时,0.1-m 的颗粒很难被清除。在完全接触模式下,在研究的典型刷子旋转速度下,可以去除 0.1 米的颗粒。完全去除 0.2-m 二氧化硅颗粒可通过仅使用去离子水的全接触刷清洁来实现。实验数据表明,高刷压和短清洁时间可以实现高去除效率(低缺陷数量)。




 本文深入探讨了CMP(化学机械抛光)工艺中颗粒的粘附及去除机制。研究发现,颗粒粘附主要由化学反应引起,尤其是在湿润和长时间老化条件下。在清洁过程中,刷子与颗粒的接触对于亚微米颗粒去除至关重要,非接触模式难以清除颗粒,而高压力和短时间的接触模式能提高去除效率。
本文深入探讨了CMP(化学机械抛光)工艺中颗粒的粘附及去除机制。研究发现,颗粒粘附主要由化学反应引起,尤其是在湿润和长时间老化条件下。在清洁过程中,刷子与颗粒的接触对于亚微米颗粒去除至关重要,非接触模式难以清除颗粒,而高压力和短时间的接触模式能提高去除效率。


















 被折叠的 条评论
为什么被折叠?
被折叠的 条评论
为什么被折叠?








