SMT 生产中,“焊膏印刷不均”“元件偏位”“虚焊”“桥连” 等问题频发,若处理不当,会导致良率骤降(如桥连会使良率从 99% 降至 80%),甚至批量返工。多数问题并非设备故障,而是参数设置、操作规范或物料适配不当导致,需通过 “现象观察→原因分析→针对性解决→预防措施” 的流程高效处理,避免盲目调整设备。
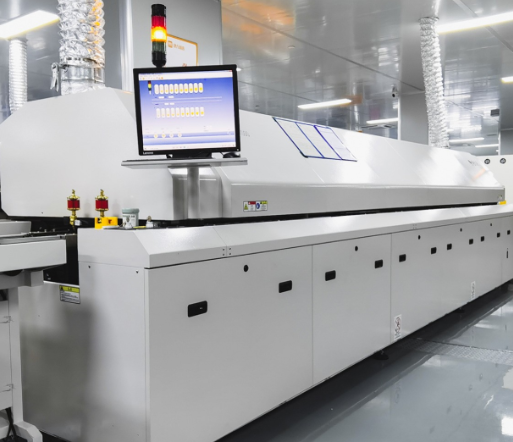
一、问题 1:焊膏印刷不均(部分焊盘焊膏量不足或过多)
现象表现
PCB 部分焊盘(如边缘或密集区域)焊膏量明显不足(覆盖面积<70%),部分焊盘焊膏溢出(覆盖面积>130%),甚至出现局部无焊膏,导致后续贴装元件无法焊接。
原因分析
钢网问题:钢网开孔堵塞(焊膏干结在孔内)、开孔尺寸不均(部分开孔过小)、钢网与 PCB 贴合不紧密(钢网变形或 PCB 翘曲);
印刷参数不当:刮刀压力不均(边缘压力小导致焊膏量不足)、印刷速度过快(焊膏未充分填充开孔)、脱模速度过快(焊膏粘连钢网);
焊膏特性:焊膏粘度异常(过高导致填充不足,过低导致溢出)、金属含量过低(<40%)。
解决方案
处理钢网问题:
-
钢网堵塞:用无尘布蘸异丙醇擦拭钢网两面,或用超声波清洗机(频率 40kHz)清洗 10 分钟,去除孔内干结焊膏;
-
开孔不均:检查钢网开孔尺寸(用卡尺测量),磨损>10% 的开孔需重新制作钢网;
-
贴合不紧密:更换变形钢网,或在 PCB 下方垫薄垫片(0.1mm 厚),补偿 PCB 翘曲(翘曲度>0.5% 时);
调整印刷参数:
-
刮刀压力:采用分段压力(边缘压力比中心高 5N,如中心 15N,边缘 20N),确保全板压力均匀;
-
印刷速度:降至 20~30mm/s(原速度>50mm/s 时),确保焊膏充分填充开孔;
-
脱模速度:降至 1~2mm/s(慢脱模),减少焊膏粘连;
优化焊膏特性:
-
粘度异常:更换合格焊膏(无铅焊膏粘度 200~300Pa・s),或回温时间延长至 4 小时(确保粘度稳定);
-
金属含量低:更换金属含量 45%~50% 的焊膏。
二、问题 2:元件偏位(贴装后元件中心与焊盘中心偏差>±0.1mm)
现象表现
贴装后的元件(如 0402 电阻、QFN 封装 IC)明显偏离焊盘中心,部分元件甚至超出焊盘边缘,导致回流焊接后虚焊或桥连。
原因分析
贴片机定位不准:视觉相机镜头污染(灰尘或焊膏残留)、Mark 点识别错误(Mark 点氧化或偏移)、吸嘴磨损(吸嘴直径变小导致吸力不足);
供料器问题:供料器送料位置偏差(轨道松动)、料带张力不均(元件在料带中偏移);
元件或 PCB 问题:元件尺寸偏差(如 0402 电阻实际尺寸 0.9mm×0.4mm,与标准 1.0mm×0.5mm 偏差过大)、PCB 焊盘偏移(印刷 Mark 点与实际焊盘偏差)。
解决方案
校准贴片机定位:
-
清洁相机镜头:用无尘布蘸镜头清洁剂擦拭,去除灰尘与焊膏残留,确保识别精度;
-
重新标定 Mark 点:删除原 Mark 点参数,重新拍摄 Mark 点(调整曝光度、对比度),定位精度校准至 ±0.01mm;
-
更换磨损吸嘴:吸嘴直径磨损>0.05mm(如原 0.3mm 直径变为 0.25mm)时,更换同型号吸嘴,确保吸力稳定(0.4~0.6MPa);
调整供料器:
-
送料位置偏差:松开供料器轨道螺丝,调整轨道至元件中心与吸嘴中心对齐,紧固螺丝后测试送料;
-
料带张力不均:更换料带(检查料带是否有褶皱),或调整供料器送料速度(与贴片机吸嘴速度匹配);
适配元件与 PCB:
-
元件尺寸偏差:更换合格元件(尺寸偏差≤±0.05mm),或重新设计钢网开孔(适配实际元件尺寸);
-
PCB 焊盘偏移:反馈 PCB 厂商修正焊盘位置,或在贴片机中设置焊盘偏移补偿(如 X 方向 + 0.05mm)。
三、问题 3:虚焊(回流焊接后焊点无润湿或空洞率>20%)
现象表现
焊点表面无光泽(呈灰白色),用镊子轻推元件,元件可轻微晃动;X-Ray 检测显示焊点内部空洞面积>20%,电气测试时导通电阻>100mΩ(标准≤50mΩ)。
原因分析
回流焊温度曲线不当:预热区温度不足(<150℃)导致助焊剂未充分活化,回流区峰值温度过低(<235℃,无铅焊膏)导致焊膏未完全融化,或保温时间过短(<30s);
焊膏或焊盘氧化:焊膏开封后暴露时间过长(>24 小时)导致氧化,PCB 焊盘氧化(沉金层厚度<0.05μm)或有油污;
元件可焊性差:元件引脚镀层氧化(如锡镀层发黄)、镀层厚度不足(<1μm),导致焊膏无法润湿引脚。
解决方案
优化回流焊温度曲线:
-
调整预热区:升温至 150~180℃,保温 60~90s,确保助焊剂活化(去除氧化层);
-
提升回流区峰值温度:无铅焊膏升至 235~245℃,保温 30~60s,确保焊膏完全融化;
-
校准炉温:用炉温测试仪(如 KIC 2000)实时监测,确保各温区温度符合曲线要求;
处理焊膏与焊盘:
-
焊膏氧化:更换开封时间<24 小时的焊膏,未用完的焊膏冷藏保存(5~10℃),避免反复回温;
-
焊盘氧化或油污:用无尘布蘸异丙醇擦拭 PCB 焊盘,去除油污;氧化严重的 PCB 需重新做表面处理(沉金);
检查元件可焊性:
-
引脚氧化:更换元件,或做浸锡处理(245℃无铅焊料浸焊 5s),去除氧化层;
-
镀层不足:反馈元件厂商,要求镀层厚度≥1μm(如锡银铜镀层)。
四、问题 4:桥连(相邻焊盘间焊膏融化后连通,形成短路)
现象表现
回流焊接后,相邻焊盘(如 IC 引脚间、密集电阻间)被焊锡连通,电气测试时相邻引脚短路(绝缘电阻<10⁶Ω),严重时导致 PCB 烧毁。
原因分析
焊膏印刷问题:钢网开孔间距过小(<0.1mm)、焊膏量过多(覆盖相邻焊盘)、印刷偏移(焊膏偏向一侧);
贴装问题:元件偏位(偏向相邻焊盘)、元件引脚间距过小(与焊盘不匹配);
回流焊问题:回流区升温速率过快(>4℃/s)导致焊膏飞溅,或峰值温度过高(>250℃)导致焊锡流动性过强。
解决方案
优化焊膏印刷:
-
钢网开孔:增大相邻开孔间距(≥0.15mm),或缩小开孔尺寸(比焊盘小 10%~15%),避免焊膏溢出;
-
控制焊膏量:降低刮刀压力(减少 5~10N),或降低焊膏粘度(通过回温调整),减少焊膏填充量;
-
校准印刷定位:调整 PCB 定位系统,确保印刷无偏移(偏移≤0.05mm);
调整贴装参数:
-
元件偏位:校准贴片机视觉定位,确保元件中心与焊盘中心偏差≤±0.05mm;
-
引脚间距不匹配:更换元件(引脚间距与焊盘间距一致),或重新设计 PCB 焊盘;
调整回流焊参数:
-
升温速率:降至 2~3℃/s,避免焊膏飞溅;
-
峰值温度:降至 235~245℃(无铅焊膏),减少焊锡流动性,避免溢出。
SMT 常见问题的解决需 “精准定位原因”—— 多数问题并非设备故障,而是参数或操作不当导致。






















 241
241

 被折叠的 条评论
为什么被折叠?
被折叠的 条评论
为什么被折叠?








