书籍:《炬丰科技-半导体工艺》
文章:底层薄膜对化学机械抛光的影响
编号:JFKJ-21-287
作者:炬丰科技
摘要
研究了基底膜对化学机械抛光去除率的影响。一个模型提出了与抛光去除率有关的力学性能,如硬度和杨氏模量。此外,提出了一种改进的浅沟槽隔离工艺与薄氮涂层,以消除盘化和氧化物残留在氮化物问题上。此外,为了减少残留颗粒和金属污染,研究了改进的化学喷雾清洗工艺。
关键词:化学-机械抛光;浅沟隔离技术
介绍
当器件的几何形状继续缩小,电路复杂性继续增长时,器件隔离成为一个难题限制电路密度的主要因素。由于横向侵蚀电场,硅氧化在生成小于微米时存在局限性。在器件上的氧化物有活性的区域,场氧化物在变薄暴露的硅的亚微米区域,非平面性,和应力诱导的硅缺陷。
实验
采用CMP抛光机,用于抛光的晶圆为200毫米本研究主要采用悬浮在碱性介质中的二氧化硅胶体。
结果与讨论

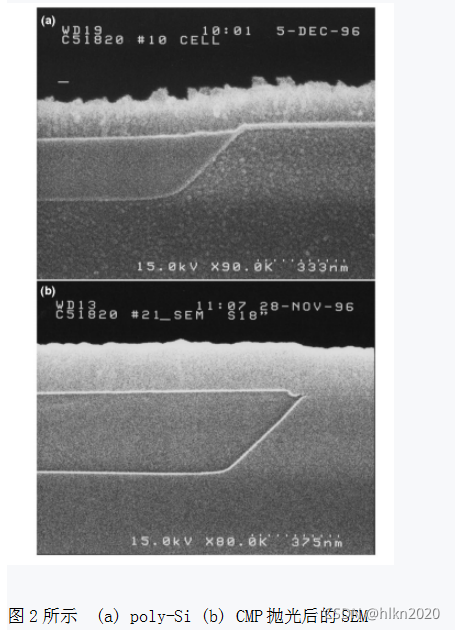


结论
这项工作研究了底层膜对STI化学机械抛光的影响。 略




 本文详细探讨了基底膜对化学机械抛光(CMP)过程中去除率的影响,包括硬度和杨氏模量等力学特性。研究还提出了浅沟槽隔离技术和氮涂层改进方案,以解决盘化和氧化物残留问题。此外,对化学喷雾清洗工艺进行了优化以减少残留颗粒和金属污染。关键词涉及CMP、浅沟隔离、氮化物、氧化物、化学清洗和抛光效率。
本文详细探讨了基底膜对化学机械抛光(CMP)过程中去除率的影响,包括硬度和杨氏模量等力学特性。研究还提出了浅沟槽隔离技术和氮涂层改进方案,以解决盘化和氧化物残留问题。此外,对化学喷雾清洗工艺进行了优化以减少残留颗粒和金属污染。关键词涉及CMP、浅沟隔离、氮化物、氧化物、化学清洗和抛光效率。

















 被折叠的 条评论
为什么被折叠?
被折叠的 条评论
为什么被折叠?








