在电子产品小型化、高功率化趋势下,铜基板凭借出色的导热性能,成为高功率器件散热的首选。某 50W LED 照明模块采用铜基板后,结温降低 20℃,寿命延长 30%。但大尺寸、厚铜层的铜基板热容量巨大,是普通 FR-4 基板的 5-10 倍,这对回流焊曲线设置带来严峻挑战。不合理的曲线会导致虚焊(不良率可达 15%)、焊点空洞(发生率 20%)等缺陷,使产品可靠性大幅下降。
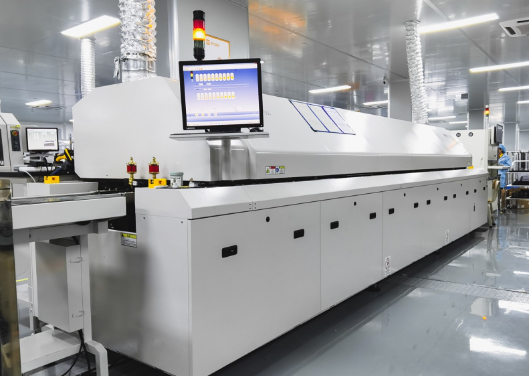
大质量铜基板的热传递特性
铜基板由铜箔、绝缘层、铜基层构成,其中铜箔(导热系数 385W/m・K)与铜基层(导热系数 380W/m・K)形成高效热传导通道。大尺寸铜基板(如 100mm×100mm)在回流焊中类似 “热沉”,热量快速被吸收并扩散至整个基板。某 PCB 批量厂家的测试显示,1mm 厚铜基板吸收同等热量后的温度上升幅度,仅为 0.2mm 厚 FR-4 基板的 1/8。
绝缘层(导热系数 0.8-1.2W/m・K)虽起到电气隔离作用,但也阻碍热量向器件焊点传递,形成热阻层。当铜基板尺寸增大、铜层加厚时,热阻效应加剧,使焊点升温滞后。例如,2mm 厚铜基板上的焊点达到焊接温度的时间,比 1mm 厚基板延迟 20-30 秒。
大质量铜基板在回流焊中升温缓慢,需更长时间、更高热量输入才能达到焊接温度。传统 FR-4 基板在升温区(1-3℃/s)可快速升温至 150℃,但同尺寸铜基板升温速率需降至 0.5-1℃/s,否则会因热应力导致基板变形、焊点开裂。某服务器电源模块的铜基板(150mm×100mm×3mm),在升温区耗时 120-150 秒才达到 150℃,比 FR-4 基板多 60-90 秒。
升温阶段的挑战与应对策略
升温速率过快,铜基板与器件间产生巨大温差,引发热应力集中。某 5mm×5mm 芯片焊接在大尺寸铜基板上,当升温速率超过 1.5℃/s 时,芯片与基板间的热应力可达 50MPa,超出芯片封装材料的承受极限(40MPa),导致芯片开裂(不良率 8%)。
大质量铜基板的热容量使升温区热量消耗大幅增加,传统回流焊炉可能无法满足需求。某 PCB 批量厂家的 8 温区回流焊炉,在处理大尺寸铜基板时,升温区实际温度比设定值低 15-20℃,导致升温速率不足,影响焊接质量。
为应对上述挑战,可采用 “阶梯式升温” 策略:先以 0.5-1℃/s 的速率将铜基板缓慢升温至 100-120℃,在此温度维持 30-60 秒,使基板各部位温度均匀化;然后以 1-1.5℃/s 的速率升温至 150℃。某汽车电子铜基板的测试显示,采用阶梯式升温后,热应力降低 30%,焊点不良率从 10% 降至 3%。
优化回流焊炉的加热系统,增加发热功率、改进热风循环设计,提高升温能力。某新型回流焊炉通过采用双加热模块和高效热风循环系统,可将大尺寸铜基板的升温速率稳定控制在 1℃/s,且温度均匀性偏差<5℃。
保温阶段的热平衡难题
保温阶段旨在使铜基板各部位、器件与焊点达到相同温度,为焊接做准备。但大质量铜基板的热扩散特性,使保温区难以维持稳定的温度场。某 120mm×80mm 铜基板在保温区,中心与边缘温差可达 10-15℃,导致边缘焊点焊接不良(不良率 12%)。
铜基板的高热容量还使保温时间需大幅延长,以确保热量充分传递至焊点。普通 FR-4 基板保温时间 60-120 秒即可,大尺寸铜基板则需 150-200 秒。若保温时间不足,焊点处助焊剂未充分活化,影响焊接润湿性,出现虚焊(发生率 18%)。
为解决热平衡难题,可采用 “分区控温” 技术:在回流焊炉保温区设置多个独立控温区域,对铜基板不同部位进行针对性加热。某 PCB 批量厂家在保温区设置 4 个控温区,通过调整各区温度,将铜基板中心与边缘温差控制在 5℃以内,焊点不良率降至 5% 以下。
优化保温区温度曲线,采用 “缓升缓降” 方式:在保温初期以 0.2-0.3℃/s 的速率缓慢升温,使热量均匀扩散;保温后期以相同速率缓慢降温,维持温度稳定。某通信基站铜基板采用此方法后,保温区温度均匀性提升 35%,焊接质量显著改善。

焊接与冷却阶段的特殊考量
铜基板的高热导率使焊接区热量迅速散失,难以维持焊点所需的焊接温度(一般比锡膏熔点高 30-40℃)。某 2mm 厚铜基板在焊接区,温度从峰值 230℃下降至 210℃的时间仅为 10-15 秒,远短于 FR-4 基板的 20-30 秒,导致焊点未充分熔化,出现冷焊(不良率 10%)。
大质量铜基板在冷却阶段散热慢,若冷却速率过快,会在基板内部产生巨大热应力,导致基板翘曲、焊点开裂。某 PCB 批量厂家的实验显示,当冷却速率超过 6℃/s 时,大尺寸铜基板的翘曲度可达 0.5mm,焊点开裂率 5%。
为确保焊接质量,需提高焊接区峰值温度并延长焊接时间:将焊接区峰值温度提升至 240-250℃,并维持 30-40 秒,保证焊点充分熔化。某工业电源铜基板采用此参数后,冷焊不良率降至 1% 以下。
优化冷却曲线,采用 “分段冷却” 策略:先以 3-4℃/s 的速率快速冷却至 150℃,释放部分热应力;然后以 1-2℃/s 的速率缓慢冷却至室温。某消费电子铜基板通过分段冷却,翘曲度控制在 0.1mm 以内,焊点开裂率<1%。
热仿真辅助曲线优化
大质量铜基板回流焊曲线的优化,需借助热仿真工具进行精准模拟。通过建立铜基板、器件、焊料的三维热模型,设置材料参数(铜基板导热系数、比热,焊料熔点、热导率等),模拟不同回流焊曲线下的温度场分布、热应力变化。某 PCB 批量厂家的优化案例显示,热仿真预测的铜基板温度分布与实际测试结果偏差<3℃,热应力预测准确率 95%。
根据热仿真结果,调整回流焊曲线各阶段参数:升温速率、保温时间、焊接温度、冷却速率等,直至得到最佳焊接效果。例如,通过仿真发现某铜基板在焊接区温度分布不均,将焊接区加热元件功率提高 15% 后,温度均匀性提升 40%,焊点质量显著改善。
热仿真还可评估不同铜基板结构(厚度、铜箔层数)、器件布局对回流焊曲线的影响,为 PCB 设计提供参考。某新型铜基板通过优化结构,使回流焊热效率提升 20%,焊接不良率降低至 3% 以下。






















 232
232

 被折叠的 条评论
为什么被折叠?
被折叠的 条评论
为什么被折叠?








