摘要
提出了一种经验自热SPICE MOSFET模型,该模型准确地描绘了垂直DMOS功率MOSFET的电和热响应。这种宏观模型实现是MOSFET建模多年发展的巅峰。这个新版本汇集了VDMOS MOSFET的热和电模型。现有的电气模型[2,3]非常准确,在业界得到认可。描述了使用参数数据的模型校准程序的顺序。新的自热MOSFET模型的仿真响应跟踪动态热响应,并且与SPICE的全局温度定义无关。
1. 引言
目前可用的许多功率MOSFET型号都是基于理想的横向MOSFET器件。它们在几个方面提供了模拟和实际电路性能之间较差的相关性。它们具有低电流和高电流的不准确性,可能会误导电源电路设计人员。模型的动态性能使这种情况更加复杂。理想的低功率SPICE 1级NMOS MOSFET模型没有考虑功率MOSFET的非线性电容特性Ciss、Coss、Crss。更高级别的SPICE MOSFET模型可用于实现具有混合结果的非线性电容。在高频应用中,对这种更高水平建模精度的需求变得明显,其中栅极电荷损失占总损失的比例变得很大。使用SPICE MOSFET模型对功率VDMOS进行建模的固有不精确性决定了需要一种替代方法;宏模型。
Wheatley和Hepp[1]定义的宏模型可以解决理想低功率SPICE MOSFET模型的缺点。通过用电阻、电容、电感和其他SPICE电路元件包围与温度无关的增益块(使用三个一级MOSFET模型实现),可以获得高度精确的结果。
可以在一次迭代中从参数测量中开发模型。从参数数据中提取模型的过程必须遵循给定的顺序。模型的许多变化会影响不同的行为。不遵循此顺序将导致重复的模型校准迭代。
2. 自热SPICE MOSFET模型
图1中的自热宏观模型是许多作者多年工作和改进的演变。该模型的一个显著优点是,在模型中实现参数数据不需要了解设备物理或工艺细节。

几个温度点的参数数据用于模型校准,从而得到一个宏模型,该模型为任何额定工作结温提供了代表性的模拟数据。
温度相关模型参数以闭环形式响应节点Tj提供的结温信息。性能与SPICE的全局温度定义无关。TEMP和温度选项TNOM,规避了NMOS模型基元的温度限制。所有MOSFET工作损耗都包含在电流源G_Pdiss中,代表热模型的瞬时功耗。
可以在不同和可变的结温下模拟多个MOSFET。每个MOSFET可以通过注释Tcase连接到散热器模型。散热器模型可能是特定于设备的,因此散热器优化成为可能。电流源G_Pdiss参考模拟地面参考,允许在桥式拓扑中使用该模型。
自热MOSFET模型的符号表示示例如图2所示。建议的符号实现是将Tj的引脚属性指定为可选(ERC=不在乎,Float=UniqueNet)。Tj是器件PN结温度的表示。它可以用作监测点,也可以连接到定义的电压源以覆盖自热功能。Tcase必须连接到散热器模型。模型的栅极、漏极和源极端子的连接处理与标准MOSFET模型没有区别。
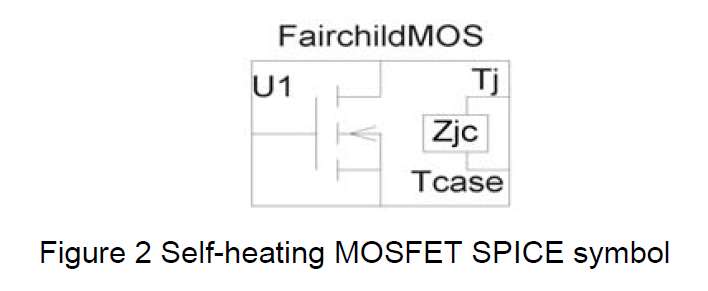
3. 自热模型的实现
将电阻的值及其温度系数描述为参考电压节点的行为模型的能力对于表达对结温的依赖性是必要的。PSPICE电阻器ABM不允许电压节点参考。如果没有电阻器ABM,MOSFET的电阻元件(表示为单独的集总元件)和二极管的电阻元件的动态温度依赖性就无法实现。
电压控制电流源ABM表达式克服了这一限制(图3)。通过使用电流源的节点进行电压控制,电阻器的行为可以表示为I=V/R(Tj)。电阻R(Tj)由依赖于结温的电压节点Tj表示的行为模型表达式代替。该电压控制电流源ABM模型用于实现RDAIN、RSOURCE和RSLC1的电压依赖表达式。
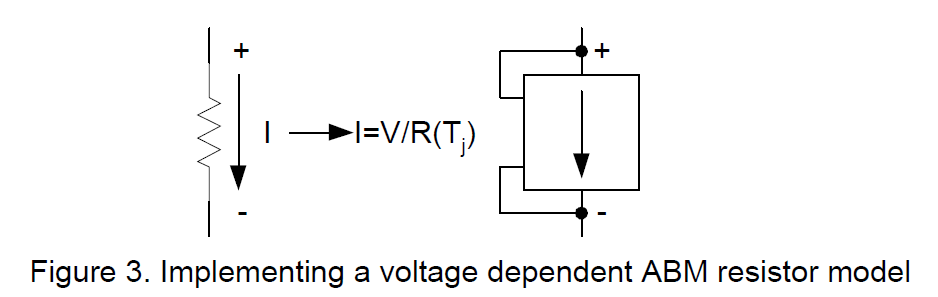
将二极管DBODY和DBREAK的温度依赖电阻元件从二极管模型中分离出来,表示为电压控制电流源ABM模型G_RDBODY和G_RDBREAK。为了提高收敛性,添加了一个非常大的电阻RDBODY。
EDBODY与DBODY串联添加,以结合本征体二极管正向导通压降的温度依赖性。
结温信息是通过包含MOSFET的热网络ZθJC和电流源G_PDISS来实现的。Fairchild Semiconductor数据表中提供了热网参数。G_PDISS计算MOS-FET瞬时工作损耗,并以电流的形式表示结果。这是表达式(1)中结温的电路形式实现

其中Tj=结温,Pdissipation=瞬时功率损耗,ZθJC=结对壳体的热阻抗,Tcase=壳体温度。热系统电模拟的单位转换如表1所示。

4. 参数提取方法
参数提取过程的顺序非常重要,因为对库的许多更改会影响不同的行为。例如,改变传递曲线中的参数会影响饱和度曲线。
推荐的方法如下。
1.传递曲线
2.饱和度曲线
3.体二极管正向导通
4.击穿电压
5.Trr
6.电容(Crss、Coss、Ciss)
7.入场费
8.温度系数
9.热模型
如果将数据绘制为对数、半对数或t等,则提取速度会更快。首次提取可能需要数天时间。随着重复使用,它变成了一个快速学习的过程。
4.1 传递曲线
三个一级MOSFET晶体管用于对从亚阈值区域到高电流的整个电流范围的增益块进行建模。三种晶体管型号是MweakMOD、MmedMOD和MstroMOD。每个晶体管的参数VTO和KP用于将模型与测量数据对齐。


添加源极电阻(G_Rsource)以降低高电流下的增益。它也是设备rDS(ON)的一个贡献因素。绘制IDS与VGS的平方根会得到线性曲线,而不是二次曲线,从而提高了daa在较高电流范围内的视觉分辨率。

4.2 饱和曲线
应使用几个栅极偏置来模拟饱和曲线。例如,要对标准栅极器件进行建模,请使用VGS=10V、5V和3.5V。G_Rdrain用于在线性区域内拟合模型。增加G_Rdrain将降低饱和曲线的电流。接下来,使用ESLC对空间电荷限制效应进行建模。ESLC中的乘数X(1e-6*X,功率的指数表达式)被调整。降低X将使高电流下的曲线变圆。如果两条饱和曲线(例如Vgs=10V和Vgs=5V)在线性区域不匹配,则可能需要重新调整强晶体管MstroMOD的KP。然后,需要重复传输曲线和饱和度曲线之间的建模,直到两条曲线都符合数据。

4.3 体二极管前向电压
通过调整Dbody-MOD中的参数IS和N,匹配低电流下的二极管曲线数据。将正向电压绘制在对数刻度上,N将调整斜率,IS将使曲线向左或向右移动。

高电流区域在线性尺度上建模。G_Rdbody用于通过添加串联电阻来匹配大电流下的二极管曲线数据,从而降低曲线。

IKF可用于平滑低电流和高电流之间的过渡区域。更换IKF后,通常需要重新调整G_Rbody。

4.4 Breakdown 电压
低电流击穿用Ebreak建模。

大电流击穿用G_Rdbreak建模。

4.5 Trr
本征体二极管反向恢复在100A/μS和最大额定直流电流下建模。体二极管DbodyMOD的参数TT用于将建模的Ta与测量的Ta相匹配。

4.6 电容
当漏极到源极电压为0.1V时,电容会移动到击穿电压。首先对Crss进行建模,设置DplcapMOD的CJO和M。CJO将调整电容曲线的水平,而M将调整斜率。接下来,使用DbodyMOD的CJO和M对Coss进行建模。这是以与Crss类似的方式完成的。最后,通过设置模型的Cin来调整输入电容Ciss。

4.7 栅极电荷
栅极电荷曲线的建模是一个四步过程(图4)。首先,通过调整Ca来调整最负栅极电压的斜率。接下来,通过调整S1A和S1B开关电压(VON和VOFF)来调整斜率断点,以考虑负电压下两个斜率之间的不连续性。S1AMOD和S1BMOD的VON和VOFF应彼此相反(S1AMOD的VON应为S1BMOD之VOFF,反之亦然)。
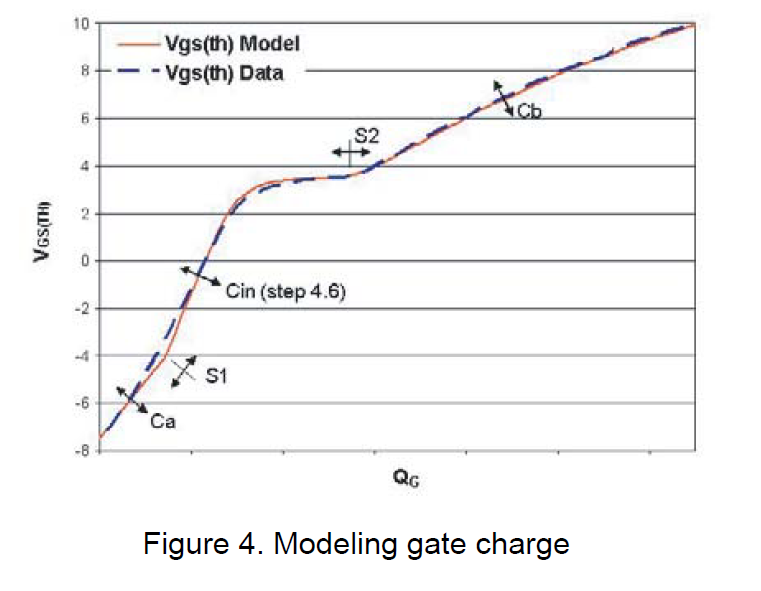

第三,调整S2A和S2B的开关电压以设置平台区域的长度。平台的电压水平将通过对传输曲线进行建模来设置,此时无法调整。S2AMOD和S2BMOD应彼此相反,如上文对S1AMOD和S1BMOD所述。第四,通过调整Cb来调整平台上方曲线的斜率。Ca和Cb的值应该几乎相同。

开关S1A至S2B的VON值应沿正向增加。每个VON值之间应至少有0.5V的间隔。将间距减小到0.5V以下可能会导致收敛误差。
4.8 温度系数
在低温和高温(例如-25℃和125℃)下重复步骤4.1至4.4。对于步骤4.2的饱和曲线,只有一个栅极偏压将用于温度系数匹配,并且应该是用于额定rDS(ON)的栅极电压。温度系数不是瞬态分析的一个因素(电容、Trr和gat电荷)。
传递曲线:在高电流下调整vDemp的温度参数。在低电流下,调整vDhres的温度参数。G_Rsource的温度系数可用于拟合高电流下的曲线。下面每行中突出显示的第一个参数是线性系数,第二个参数是平方函数系数。

饱和曲线:首先调整G_Rdrain的温度参数。然后对G_RSLC1的温度参数进行建模。这模拟了温度下的空间电荷限制效应。

体二极管正向电压:在低电流下,正向电压用EDbody的温度系数建模。EDbody中的最后一个参数用于将Vf限制在175℃以上。G_Rdbody的热参数用于模拟高电流区域。

击穿电压:低电流击穿用Ebreak的热参数建模。G_Rdbreak的热参数用于模拟大电流。

4.9 热模型
热模型独立于电模型进行建模。组件CTHERM1至CTHERM6和RTHERM1至RTHERM6用于将模拟的热阻抗曲线拟合到测量数据。为了确保良好的热模型,热电容器的值应从CTHERM1增加到CTHERM6。从RTHERM1到RTHERM6,热敏电阻的值也应增加。

5. 仿真结果
MOSFET FDP038AN06A0的仿真结果和参数数据如图4、5、6、7所示,包括栅极电荷、栅极阈值、rDS(ON)和导通饱和电压。两者一致性很高。
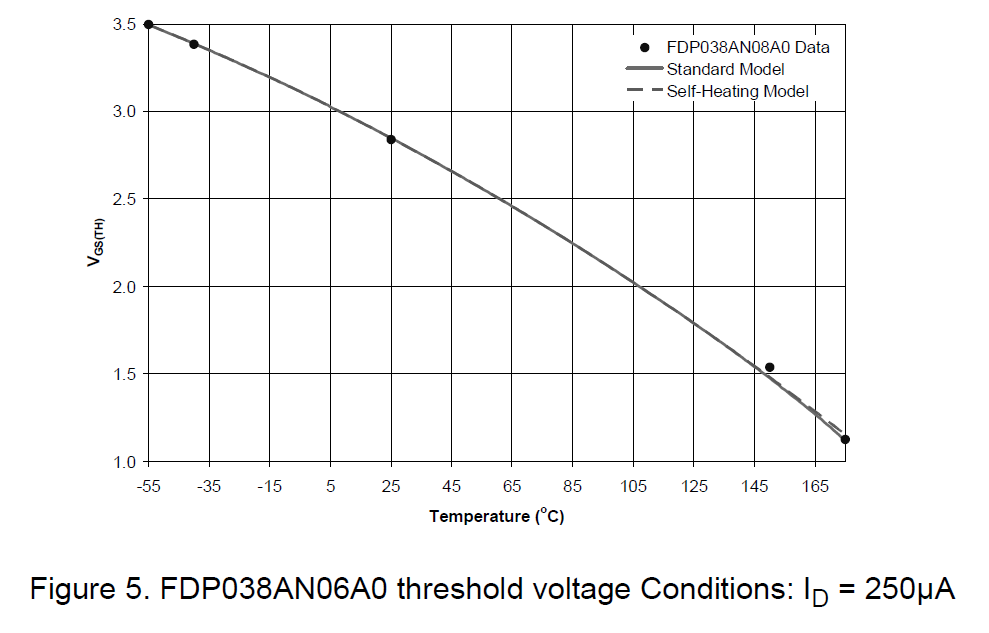
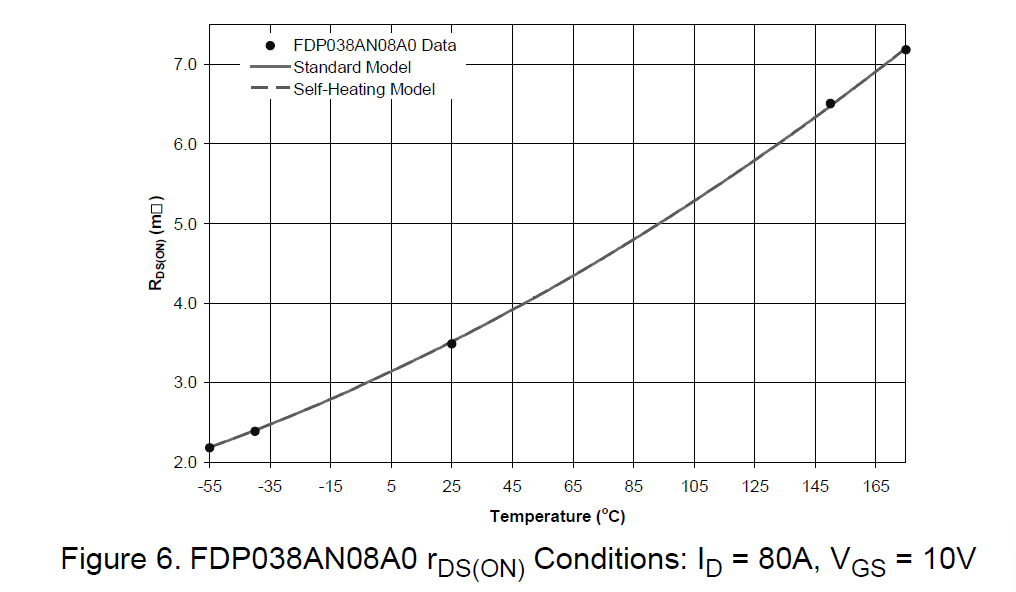
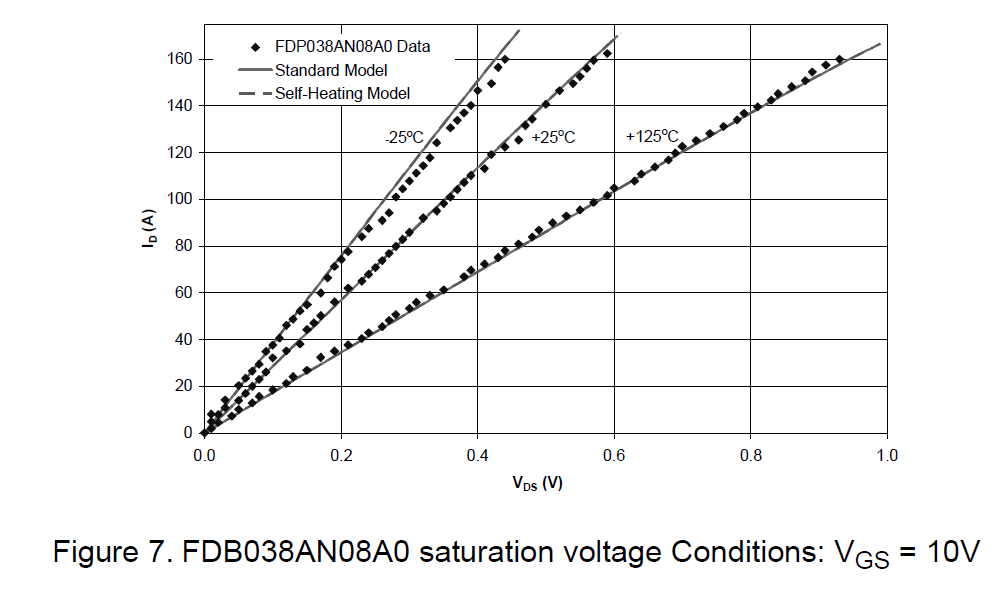
6. 仿真收敛
自热模型在多种电路配置下进行了测试。发现它在数值上是稳定的。如果PSPICE的设置选项ABSTOL设置小于1μA,则在一些大信号模拟下可能会出现收敛失败。
UIS模拟[10]是在具有500MHz Pentium III处理器和256MB RAM的Dell Latitude CSx上进行的。操作系统是Windows 2000,启用病毒扫描软件。使用PSPICE v9.1版。
仿真时间:
标准模型:7.9s
自加热模型:13.7s
当发生显著和快速的结温变化时,自热模型的仿真时间会更长。这是结温反馈对MOSFET温度相关参数的动态相互作用的结果。
7. 未来模型的发展
如果将之前发布的飞兆半导体MOSFET模型修改为自热模型,但完全在器件参数容差范围内,则会引入轻微的不准确性。通过在器件特定模型校准期间在1级NMOS MOSFET中包含变量T_ABS=25,可以消除这种不准确,从而使模型与新的自热模型完全兼容。该术语用于FDP038AN06A0的标准MOSFET模型校准。通过在体二极管两端添加结温依赖电流源,可以引入自热模型固有体二极管漏电流的温度依赖性。
8. 总结
自热PSPICE功率MOSFET宏模型为电路仿真精度提供了下一个进化步骤。包含与温度敏感MOSFET电参数耦合的热模型导致自热PSPICE MOSFET宏模型,该模型允许在时域模拟期间提高精度。现在可以对时域模拟期间功耗引起的温度变化的影响进行建模。





















 80
80

 被折叠的 条评论
为什么被折叠?
被折叠的 条评论
为什么被折叠?








