一.IGBT器件
| IGBT(绝缘栅双极晶体管) | IGBT是输入部为MOSFET结构、输出部为BIPOLAR结构的元器件,通过这两者的复合化,既是使用电子与空穴两种载体的双极元件,同时也是兼顾低饱和电压(与功率MOSFET的低导通电阻相当)和较快的开关特性的晶体管。 |
| MOSFET | 是指半导体元件的结构为Metal(金属)- Oxide(半导体氧化物)- Semiconductor(半导体)的三层结构的Field-Effect Transistor(场效应晶体管)。 |
| BIPOLAR | 是指使用了双极性元件,将称为p型和n型的两种半导体构成n-p-n及p-n-p结构的电流工作型晶体管。 |
二.碳化硅功率器件
| SIC功率模块 | 分为由SiC MOSFET + SiC SBD构成的类型和只由SiC MOSFET构成的类型两种 |
| SIC SBD | 使用SiC可以通过具有高速特点的器件结构——SBD(肖特基势垒二极管)结构实现600V以上的高耐压二极管。因此,用SiC SBD替换FRD(快速恢复二极管),能够显著减少反向恢复损耗。 |
| SIC MOSFET | SiC器件的漂移层电阻比Si器件低,因此可以通过具有高速器件结构特点的MOSFET同时实现高耐压和低阻值。 |
三.氮化镓功率器件
| GaN HEMT | 高电子迁移率晶体管是使用了电子迁移率高的半导体材料的晶体管,可实现高速开关(高频工作) |
四.参数特点
| (特性)Properties | Si | 4H-SiC | GaAs | GaN |
| (晶体结构)Crystal Structure | Diamond | Hexagonal | Zincblende | Hexagonal |
| (禁带宽度)Energy Gap: EG(eV) | 1.12 | 3.26 | 1.43 | 3.5 |
| (电子迁移率)Electron Mobility: μN(cm2/VS) | 1400 | 900 | 8500 | 1250 |
| (空穴迁移率)Hole Mobility: μP(cm2/VS) | 500 | 100 | 400 | 200 |
| (击穿场强)Breakdown Field: EB(V/cm)×106 | 0.3 | 3 | 0.4 | 3 |
| (热导率)Thermal Conductivity (W/cm°C) | 1.5 | 4.9 | 0.5 | 1.3 |
| (饱和漂移速度)Saturation Drift Velocity: VS(cm/s)×107 | 1 | 2.7 | 2 | 2.7 |
| (相对介电常数)Relative Dielectric Constant: εS | 11.8 | 9.7 | 12.8 | 9.5 |
| (p型/n型控制)p. n Control | ○ | ○ | ○ | △ |
| (热氧化)Thermal Oxide | ○ | ○ | × | × |
| ○ : 良好/可行 |
| △ : 困难/有限制 |
| × : 不可行/差 |
五.应用场景
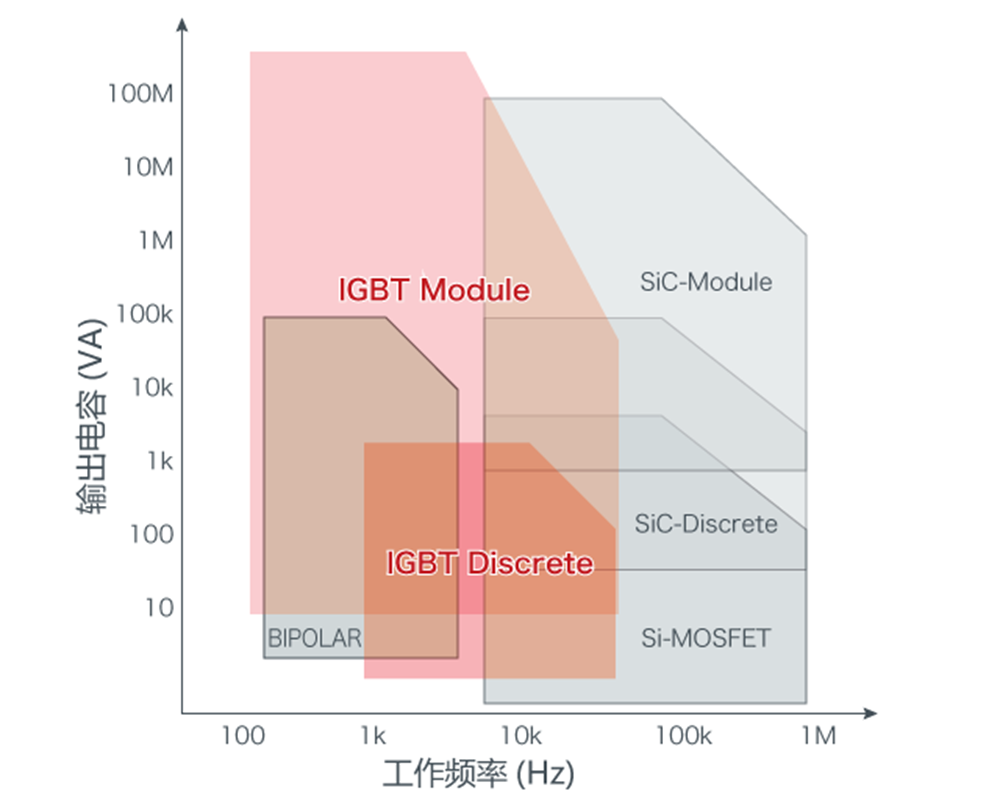
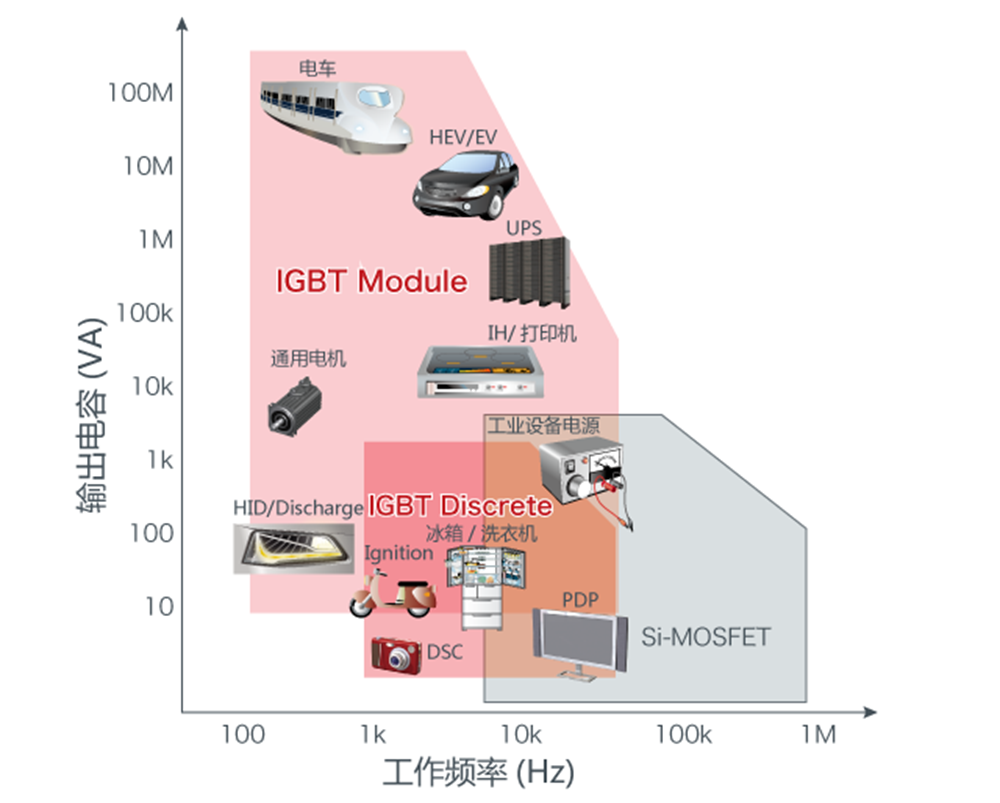
 Si/SiC/GaN器件对比分析
Si/SiC/GaN器件对比分析






















 2593
2593

 被折叠的 条评论
为什么被折叠?
被折叠的 条评论
为什么被折叠?










