
聚焦离子束(FIB)技术利用一束聚焦的离子(如镓离子)与材料表面相互作用,实现高精度的加工和分析。它类似于扫描电子显微镜(SEM),但使用离子束而非电子束,能够在纳米尺度上操作样品。FIB最初用于半导体行业,如今已扩展到生物学、材料科学等多个领域。
1. FIB如何工作?
聚焦离子束(FIB)技术是一种利用高能离子束与材料相互作用的微纳加工技术,其核心在于液态金属离子源(通常为镓),通过电场激发生成离子流,并利用静电透镜将离子束聚焦至直径仅几纳米。
当离子束轰击样品表面时,会引发物理和化学反应,包括溅射(移除表面材料)、离子植入(改变材料内部结构)和二次电子/离子发射(用于成像)。
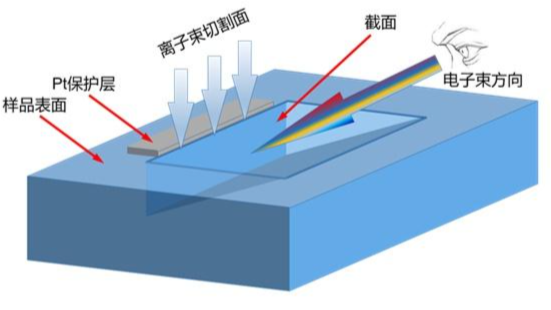
2.FIB的主要功能
IB技术的主要功能包括高分辨率成像、精确刻蚀、材料沉积和分析。
成像功能通过收集二次电子或离子生成样品表面和内部结构的清晰图像,分辨率可达亚纳米级。
刻蚀功能以纳米级精度移除材料,用于制备透射电子显微镜(TEM)样品或修改微电路。
沉积功能通过引入特定气体(如含金属前驱体气体)在样品表面沉积材料,用于修复缺陷或构建功能结构。
分析功能则结合EDS或EBSD等技术,表征材料的元素组成和晶体结构。这些功能使FIB在多个领域表现出色。
【原文阅读】![]() https://mp.weixin.qq.com/s/AwrrKmkvE9eRWNSm-P1rPQ
https://mp.weixin.qq.com/s/AwrrKmkvE9eRWNSm-P1rPQ
3.FIB技术与其他技术的结合
(1)FIB-SEM结合
FIB-SEM系统将离子柱和电子柱整合于一体,形成双束显微镜,广泛用于样品制备和成像分析。该结合通过FIB的精确铣削和SEM的高分辨率成像,提供从表面到深层结构的全面观察,尤其适用于三维断层成像和微观结构分析。
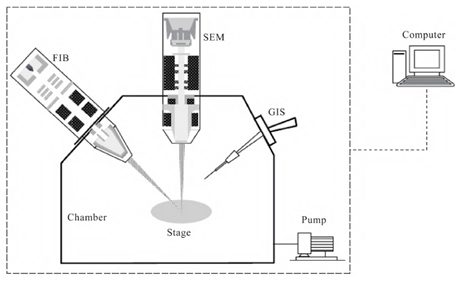
-
样品制备要求
制备过程首先使用SEM定位感兴趣区域,确保加工精度。随后,在目标区域沉积铂保护层,以防止离子束直接损伤样品表面。FIB铣削分为两步:粗铣削使用高电流(如10 nA)快速移除材料,精细铣削使用低电流(如100 pA)抛光表面,确保平整度,适合高分辨率成像或TEM样品制备。
对于三维断层成像,FIB逐层铣削(每次移除几十纳米),SEM同步成像以重建三维结构。样品需固定在导电基底上,避免充电效应影响SEM成像,制备过程中通过二次电子图像实时监控铣削进度。
-
功能
FIB-SEM提供高分辨率二次电子和背散射成像,分辨率可达亚纳米级,用于表征形貌和结构。三维断层成像通过FIB逐层铣削和SEM连续成像,实现纳米级三维结构重建,广泛应用于材料科学和生物学。
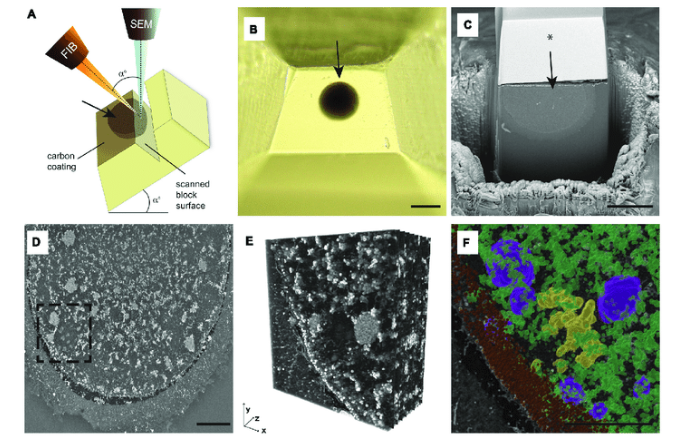
FIB-SEM成像过程及数据处理概览。(A)FIB-SEM装置示意图。聚焦离子束(FIB)和扫描电子显微镜(SEM)的电子柱均位于显微镜腔室内,两者的目标点为样品块表面的重合点。载物台的倾斜角度对应于FIB与SEM电子柱之间的夹角(α)。树脂块表面顶部涂有一层碳层。卵母细胞的位置用箭头表示。(B)修整后的树脂块顶部视图,其中嵌有样品(箭头所示)。(C)被切出凹槽的树脂块,其中包含半个卵母细胞(箭头所示)。树脂块表面涂有一层薄碳层,样品上方放置了一个硅掩膜(*)。(D)利用FIB-SEM扫描得到的成熟中期II(MII)卵母细胞表面的单色灰度图像。(E)纺锤体区域的三维重建图像(对应于面板(D)中的虚线矩形区域)。(F)纺锤体区域内经三维分割并伪着色的染色体(黄色)、线粒体(绿色)、管状内质网(品红)和皮质颗粒(棕色)[对应于(D)中虚线矩形区域]。比例尺:100 µm(B),50 µm(C),10 µm(D、F)。
论文标题:High-Resolution 3D Reconstruction of Human Oocytes Using Focused Ion Beam Scanning Electron Microscopy
系统还可配备EDS探测器进行元素定量分析,或EBSD探测器进行晶粒取向映射。此外,FIB支持材料沉积,用于修复电路或构建纳米结构。需注意,离子束可能引起表面损伤或镓植入,影响分析质量。
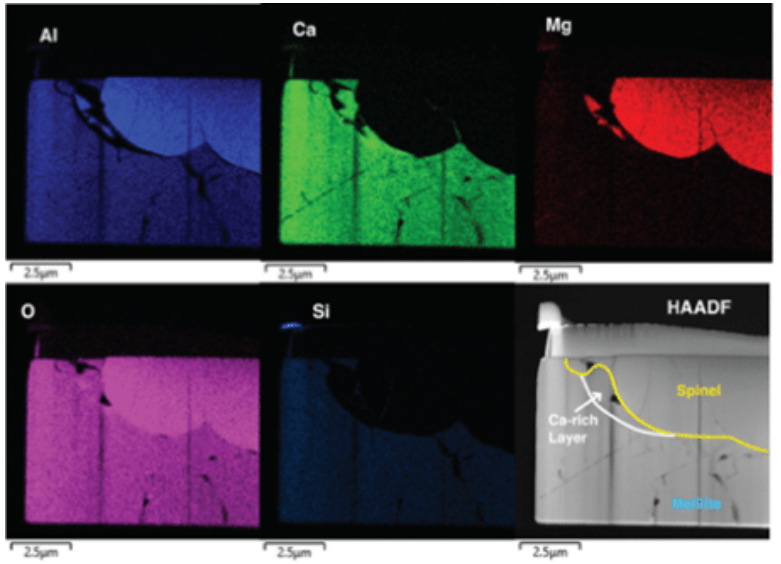
FIB切片的EDS图谱
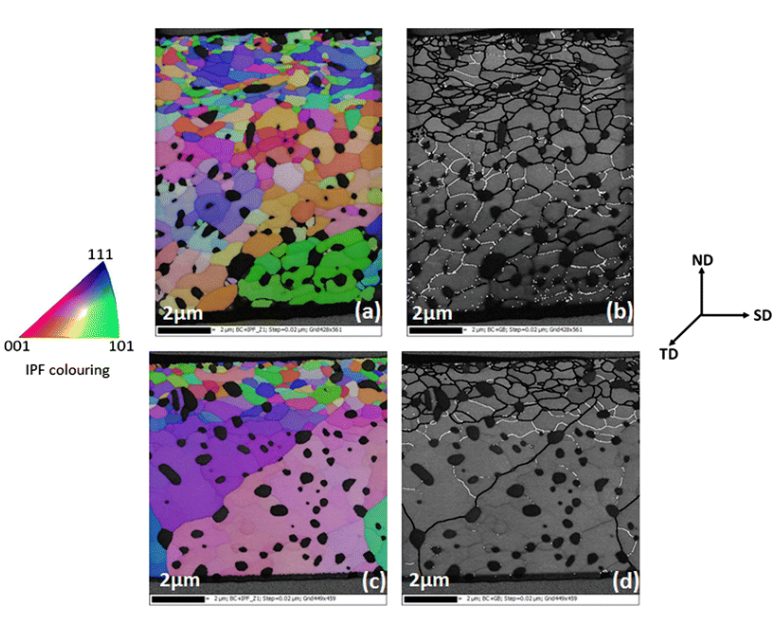
从磨损表面中心提取的FIB薄片的横截面EBSD图像
论文标题:Industrial Gear Oils: Tribological Performance and Subsurface Changes
(2)FIB-TEM结合
FIB-TEM结合利用FIB的精确铣削能力,为TEM制备超薄样品,支持原子级分辨率的内部结构分析。该技术在研究纳米结构和晶体缺陷时尤为重要。
-
样品制备要求
制备过程从SEM定位感兴趣区域开始,随后沉积铂保护层以保护样品。FIB通过铣削大型沟槽隔离目标区域,逐步减小离子束电流,制备约500 nm厚的薄膜。样品倾斜45°后,继续抛光两侧和底部,仅保留顶部铂条固定薄膜。最后,使用低电流(如100 pA)精细铣削至100 nm以下,并通过纳米操作器将薄膜转移至TEM铜网格。整个过程需实时监控,避免过度铣削或损伤。
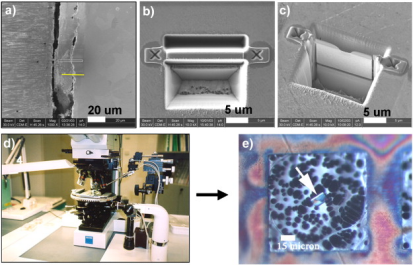
-
功能
FIB-TEM支持亚埃级分辨率的原子成像,揭示晶界、缺陷和纳米颗粒等细节。结合选区电子衍射(SAED)可分析晶格结构和取向,配合EDS可进行元素分布映射。
该技术在材料科学中用于表征纳米结构和界面,在半导体行业中用于分析晶体缺陷和器件结构。需优化铣削参数并使用低温操作,以减少镓植入或样品非晶化对TEM图像的影响。
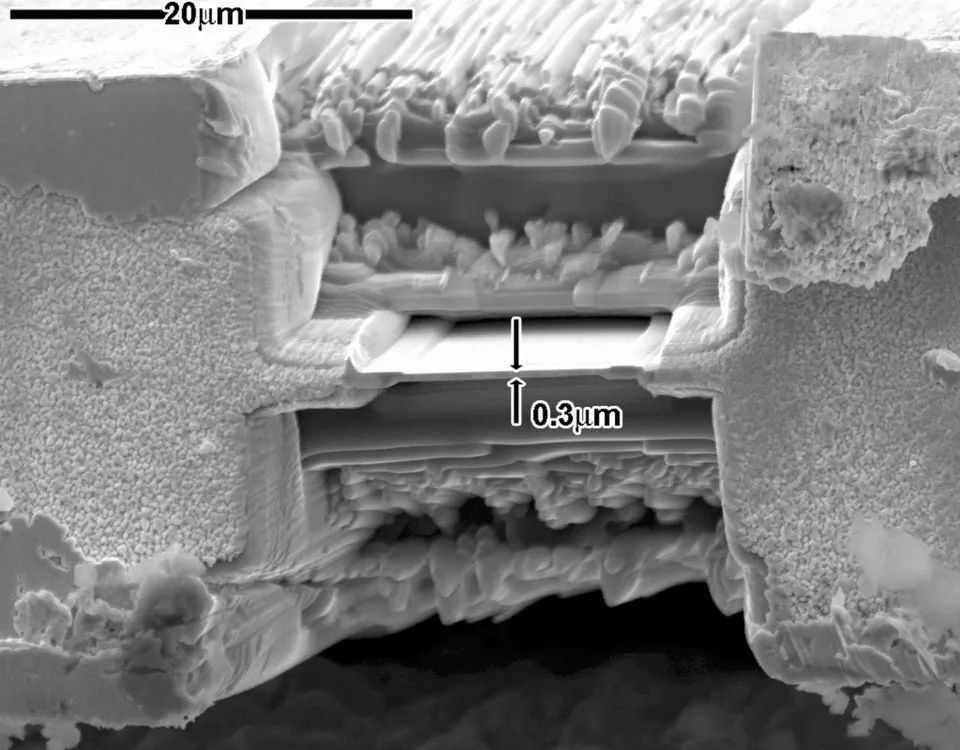
版权声明
本文来源:除特别注明原创授权转载文章外,其他文章均为转载,版权归原作者或平台所有,仅用于学术分享。如有侵权请联系小编删除。编辑:元素魔方科研服务

























 3597
3597

 被折叠的 条评论
为什么被折叠?
被折叠的 条评论
为什么被折叠?










