书籍:《炬丰科技-半导体工艺》
文章:超薄硅片键合
编号:JFKJ-21-517
作者:炬丰科技
摘要
超薄硅晶片是指弗吉尼亚半导体公司制造的材料,其厚度小于 200微米,超出了普通晶片抛光技术的限制。超薄硅晶片为获得薄铤合结构提供了新的选择。超薄晶片可以直接键合到衬底上。粘合方法是将一对镜面抛光的硅表面在清 洁的气氛中相互接触,在表面之间形成“接触波”形式的 弱粘合。结合通过随后的退火完成,增强了界面结合能。 粘合程序和试验结果

电探测器机构
光电探测器是一种吸收光能并将其转化为电能的电子设 备。主要机制取决于半导体带隙的概念,依靠该间隙工作的半导体探测器称为本征探测器。
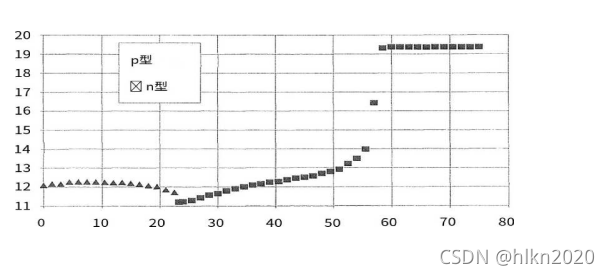
晶圆制备和焊接
用于制造光电探测器的晶圆有: 表5』光电探测器用晶片规格。
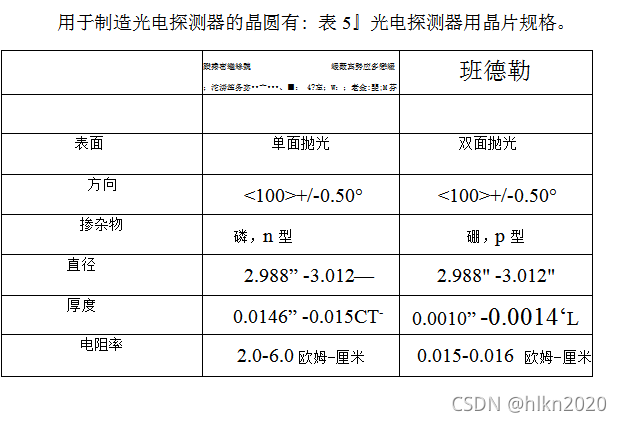

结论和总结
绝缘体上硅、硅上硅和微机电领域的硅直接键合技术的快速发展表明,这是一个非常有前途的领域。室温下的吸引力是由吸附在 两个晶片表面上的羟基和水分子之间的氢键引起的。实验表明,结合力取决于表面粗 糙度、化学特性等因素。灰尘颗粒的数量、表面的粗糙度和化学特性、退火的时间和温度都会影响空隙的形成。通过氧 化预清洗、适当的退火温度和提高表面光洁度,可以消除大部分空隙。测量表明,用不同厚度的键合超薄晶片对制作光电探测器是可行的。
 超薄硅片键合技术在光电探测器制造中的应用
超薄硅片键合技术在光电探测器制造中的应用




 本文介绍了超薄硅片键合技术,这是一种用于制造光电探测器的新方法。超薄硅晶片,厚度小于200微米,通过直接键合到衬底上来创建薄键合结构。键合过程涉及清洁气氛中的镜面抛光硅表面接触,随后的退火增强界面结合。此外,讨论了影响键合质量的因素,如表面粗糙度、化学性质和退火条件。光电探测器的工作原理依赖于半导体带隙,而键合技术的进步对于绝缘体上硅、硅上硅和微机电系统的未来发展具有重要意义。
本文介绍了超薄硅片键合技术,这是一种用于制造光电探测器的新方法。超薄硅晶片,厚度小于200微米,通过直接键合到衬底上来创建薄键合结构。键合过程涉及清洁气氛中的镜面抛光硅表面接触,随后的退火增强界面结合。此外,讨论了影响键合质量的因素,如表面粗糙度、化学性质和退火条件。光电探测器的工作原理依赖于半导体带隙,而键合技术的进步对于绝缘体上硅、硅上硅和微机电系统的未来发展具有重要意义。

















 1万+
1万+

 被折叠的 条评论
为什么被折叠?
被折叠的 条评论
为什么被折叠?








