近年来,芯片行业深陷大国博弈的风口浪尖。国内芯片产业的 “卡脖子” 难题,更多集中于芯片制造环节,尤其是光刻机、光刻胶等关键设备和材料领域。作为现代科技的核心,芯片的原材料竟是生活中随处可见的沙子。从沙子到芯片,需历经数百道工序。下面,让我们深入了解芯片的制造流程。

一、从沙子到硅片(原材料阶段)
沙子由氧和硅组成,主要成分是二氧化硅。芯片制造的首要步骤就是将沙子中的二氧化硅还原成硅锭,之后经过提纯,得到一根根长长的硅棒。硅棒需依次进行研磨、切割、抛光等处理,得到厚度<1mm的镜面硅片,这一阶段在硅片厂商进行
整体流程为:沙子→硅熔炼→单晶硅锭→硅锭切割→硅片
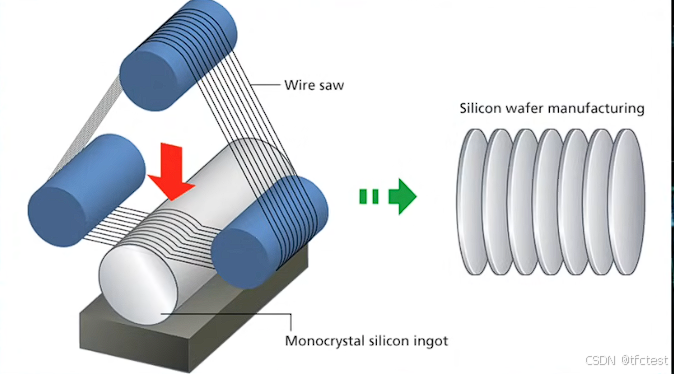
二、晶圆制造(核心工艺)
硅片生完完后,便进入晶圆厂开启复杂的加工工序在光秃秃的硅片上表面均匀涂抹光刻胶,利用光刻机进行曝光,将掩模版上的电路图案转移到光刻胶上。曝光后,对曝光细节进行处理,再溶解掉不需要的光刻胶。蚀刻与清洗:通过蚀刻技术,将光刻后暴露出来的晶圆部分进行刻蚀,形成所需的电路结构。最后,清除残留的光刻胶,得到了包含数百枚的晶圆,这一阶段由晶圆厂进行。整体流程为:光刻胶→曝光→曝光细节处理→溶解光刻胶→蚀刻→清除光刻胶→晶圆

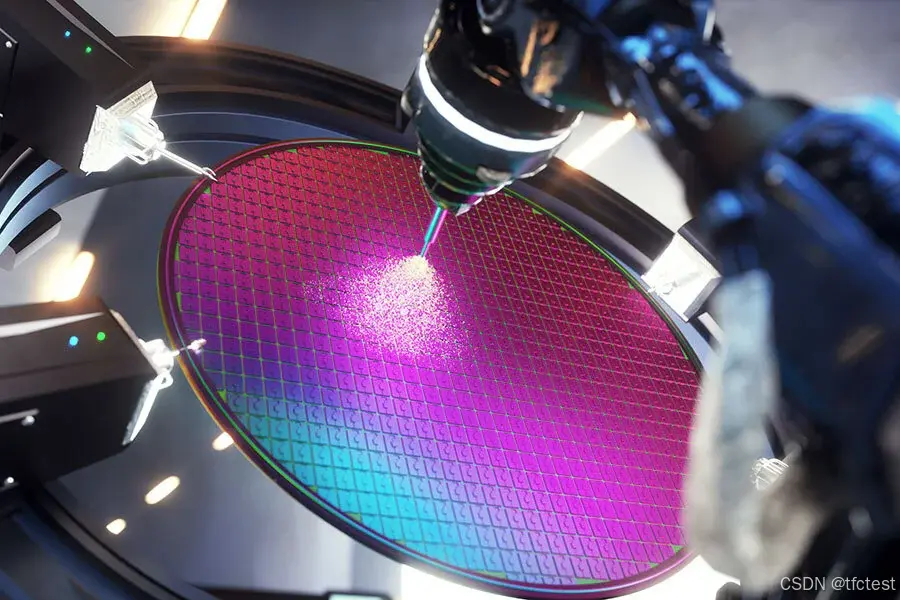
三、CP测试即晶圆级测试
晶圆上单个Die的故障率可达5%-20%,为了减少封装成本,都需进行CP测试(即晶圆级测试)可降低30%封装成本,基于ATE测试平台开发CP测试程序,ATE测试平台通常采用PXIe模块化仪器,搭配国产海量互连接口,形成一个可扩展、通用的测试平台,满足芯片的高精度、高效的测试需求

四、芯片封装
CP测试合格后,晶圆进入芯片封装阶段对晶圆进行切割,取出合格的芯片裸片(Pass Die),形成单颗Die,将单颗Die与基板、金属散热片进行封装,保护芯片并实现电气连接与散热。
整体流程为:晶圆切割→取出Pass Die→单颗Die→基板、Die 和金属散热片→封装
五、FT测试 —芯片级最终把关
封装完成后,进行FT测试,即芯片级测试,这是芯片出货前的最后一道测试工序,对保障芯片质量至关重要,基于ATE测试平台开发CP测试程序。
芯片制造是一场涉及千亿级投入的"马拉松",尽管我国目前自主化程度不高,国产化率仍不足15%,但通过材料(硅片)、设备(光刻机)、测试(ATE)三大环节的垂直突破,可实现从上游的硅片制造,到中游的晶圆、芯片制造,实现芯片产业链的完全自主可控。




















 874
874

 被折叠的 条评论
为什么被折叠?
被折叠的 条评论
为什么被折叠?








