书籍:《炬丰科技-半导体工艺》
文章:x射线相衬成像的各向异性硅蚀刻
编号:JFKJ-21-246
作者:炬丰科技
摘要
基于实验室的x射线相位对比成像系统一直专注于医学应用,但对低密度材料的无损分析的材料科学应用的兴趣日益浓厚。将这种成像技术扩展到密度更高的材料或更大的样品,以允许使用更高能量的x射线源。在这项工作中,我们演示了使用各向异性硅蚀刻氢氧化钾,以实现极高的纵横比光栅。这种方法已经被证明是有效的制造深度,均匀光栅利用不同晶面的刻蚀选择性硅。
介绍
基于光栅的x射线相位对比成像实验室实现依赖于微加工光栅:源光栅、相位光栅和分析仪光栅。源光栅和分析光栅都是透射光栅;它们的深度决定了可以达到的对比度。
实验细节

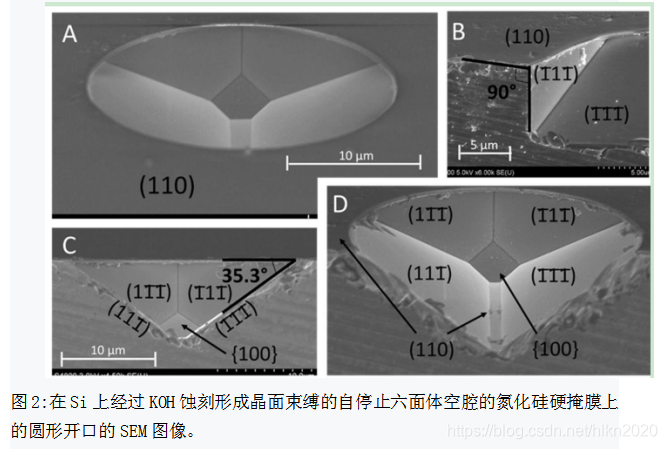
结果与讨论
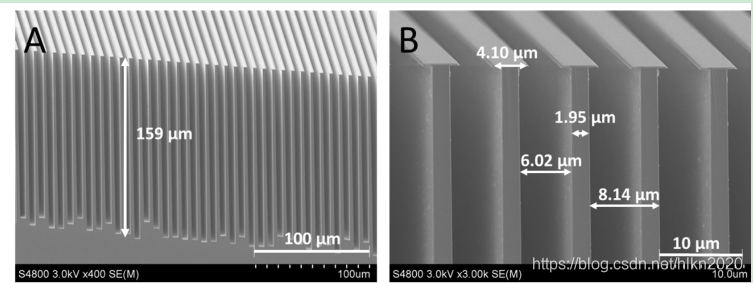
KOH蚀刻的衍射光栅的横截面扫描电镜图像,深度159µm,在90分钟内产生了令人印象深刻的80:1纵横比特征。SEM图像显示,侧壁轮廓直,8µm间距均匀,Si翅片宽度接近2µm, Si3N4硬掩膜咬边约1µm。
结论 略




 该研究展示了利用各向异性硅蚀刻技术,通过氢氧化钾(KOH)处理,成功制造出深度159μm、纵横比达80:1的硅光栅。这一方法确保了侧壁轮廓平直,8μm间距均匀,且Si3N4硬掩膜边缘清晰。这种技术对于高密度材料的无损分析和光栅制造具有重要意义。
该研究展示了利用各向异性硅蚀刻技术,通过氢氧化钾(KOH)处理,成功制造出深度159μm、纵横比达80:1的硅光栅。这一方法确保了侧壁轮廓平直,8μm间距均匀,且Si3N4硬掩膜边缘清晰。这种技术对于高密度材料的无损分析和光栅制造具有重要意义。

















 被折叠的 条评论
为什么被折叠?
被折叠的 条评论
为什么被折叠?








