在 SMT 生产中,沉锡板(ImSn 板)的 “焊接寿命” 并非永恒 —— 每经历一次回流焊,它的可焊性就会悄悄衰减。就像手机电池用久了续航会下降,沉锡板多次回流后,焊锡在焊盘上的 “铺展能力” 会逐渐变差,甚至出现虚焊。而 “可焊性衰减曲线” 就是记录这一变化的 “体检报告”,能直观告诉工程师:沉锡板经历几次回流后还能正常焊接?
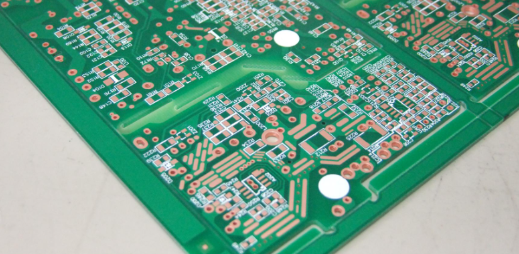
一、先搞懂:可焊性衰减曲线是什么?核心指标有哪些?
可焊性衰减曲线,简单说就是 “回流次数” 与 “可焊性指标” 的关系图 —— 横轴是回流次数(1 次、2 次、3 次…),纵轴是可焊性核心指标,通过曲线能清晰看到可焊性随回流次数的变化趋势。
衡量沉锡板可焊性的核心指标有两个,就像判断一杯奶茶好不好喝要看 “甜度” 和 “口感”:
润湿角:焊锡熔融后与焊盘形成的夹角,≤45° 为合格(角度越小,焊锡越容易铺展);
焊锡铺展率:焊接后焊锡实际覆盖面积与焊盘设计面积的比值,≥80% 为合格(比值越高,焊接越充分)。
我们以常见的 1.5μm 厚沉锡板(SAC305 无铅锡膏,回流峰值 245℃)为例,通过实测绘制出可焊性衰减曲线,看看它的变化规律。
二、实测衰减曲线:三次回流是 “关键拐点”
通过对 50 块沉锡板进行 1-5 次回流测试,我们得到了一组典型的可焊性衰减数据,绘制成曲线后呈现出 “先缓后陡” 的特点,具体可分为三个阶段:
1. 第 1-2 次回流:可焊性 “轻微衰减”(曲线平缓段)
-
第 1 次回流后:润湿角平均 28°,铺展率 95%(优秀)—— 此时沉锡层新鲜,锡纯度高,焊锡能快速与沉锡层反应,形成均匀合金层;
-
第 2 次回流后:润湿角升至 35°,铺展率 90%(良好)—— 可焊性开始衰减,但仍在合格范围内。这是因为第一次回流后,沉锡层表面形成了极薄的氧化锡(SnO₂),厚度约 5-10nm,就像给焊盘盖了层 “透明保鲜膜”,轻微阻碍了焊锡润湿。
这个阶段曲线平缓,衰减幅度小(润湿角增加 7°,铺展率下降 5%),说明沉锡板在两次回流内,可焊性基本能满足生产需求,适合需要 1 次返修的产品(如手机主板)。
2. 第 3 次回流:可焊性 “加速衰减”(曲线拐点)
-
第 3 次回流后:润湿角骤升至 43°(接近合格上限),铺展率降至 82%(临界合格)—— 这是衰减曲线的 “关键拐点”,可焊性从 “良好” 向 “临界” 跨越。
为什么会出现拐点?因为三次回流后,沉锡层发生了两个关键变化:
-
氧化层增厚:表面氧化锡厚度从 10nm 增至 20nm 以上,“保鲜膜” 变厚,焊锡需要更多能量才能突破氧化层;
-
合金层过度生长:沉锡层与底层铜箔反应形成的 Cu₆Sn₅合金层,厚度从 2μm 增至 4μm,这种过厚的合金层可焊性差,就像在焊盘上盖了层 “硬壳”,焊锡难以与之结合。
某 PCB 厂的生产数据显示:第 3 次回流后,沉锡板的焊接不良率从 2% 升至 8%,主要问题是 “焊锡缩球”(焊锡无法铺展,缩成小球)。
3. 第 4-5 次回流:可焊性 “断崖式下跌”(曲线陡峭段)
-
第 4 次回流后:润湿角达 52°(不合格),铺展率降至 75%(不合格);
-
第 5 次回流后:润湿角 60°,铺展率仅 68%—— 此时沉锡板基本失去可焊性,即使勉强焊接,焊点拉力值也会下降 30% 以上,在振动环境中极易开裂。
这个阶段曲线陡峭,是因为:
-
氧化层出现 “裂纹”:多次高温让氧化锡层脆化开裂,水汽和氧气顺着裂纹进入沉锡层内部,引发 “深层氧化”;
-
沉锡层 “耗尽”:1.5μm 厚的沉锡层经过 5 次回流后,大部分锡已与铜反应生成合金,剩余纯锡不足 0.5μm,焊锡失去 “反应对象”,自然无法铺展。
三、哪些因素会让衰减曲线 “更陡”?三个关键影响变量
同样是沉锡板,不同条件下的衰减曲线差异很大,以下三个因素会让可焊性衰减更快,曲线更陡峭:
1. 沉锡层厚度:越薄衰减越快
-
1.0μm 薄沉锡板:第 2 次回流后润湿角就达 42°(临界),第 3 次直接不合格;
-
2.0μm 厚沉锡板:第 3 次回流后润湿角仍能保持 38°,第 4 次才接近临界 —— 厚沉锡层就像 “储备粮更多”,能延缓合金层过度生长和锡耗尽的速度,让衰减曲线平缓 1-2 个回流周期。
2. 回流后存储环境:高湿环境是 “加速器”
如果沉锡板回流后存放在高湿环境(85% RH),衰减曲线会比干燥环境(40% RH)陡 30%:
-
高湿环境下,第 3 次回流后润湿角达 48°(不合格);
-
干燥环境下,第 3 次回流后润湿角仍为 41°(临界合格)—— 因为高湿会加速氧化层生长,就像潮湿天气金属更容易生锈,沉锡层的氧化速度会翻倍。
3. 回流峰值温度:温度越高衰减越快
如果回流峰值从 245℃升至 260℃(比如焊接大功率元件),衰减曲线会明显变陡:
-
260℃下,第 2 次回流后铺展率就降至 83%(临界);
-
245℃下,第 2 次回流后铺展率仍有 90%—— 高温会加速锡与铜的反应,让合金层快速增厚,同时加剧氧化,相当于 “给可焊性衰减踩了油门”。
四、如何让衰减曲线 “变平缓”?三个实用延缓策略
知道了衰减规律,我们就能针对性延缓可焊性衰减,让沉锡板 “焊接寿命” 更长:
1. 选择厚沉锡层:给焊盘 “多囤粮”
极寒环境或需要多次返修的产品(如汽车电子),建议选择 2.0-2.5μm 厚的沉锡层 —— 实测显示,2.0μm 沉锡板比 1.0μm 的可多承受 1-2 次回流,第 4 次回流后仍能保持合格可焊性。但要注意,沉锡层不能超过 3μm(否则会导致微盲孔堵塞,参考之前聊过的沉锡层厚度对微盲孔的影响)。
2. 回流后真空存储:给焊盘 “穿防护衣”
沉锡板每次回流后,立即用真空包装(含干燥剂)存储,能减少氧化和水汽侵蚀。某通讯设备厂的实践显示:真空存储的沉锡板,第 3 次回流后润湿角比普通存储低 5°,铺展率高 8%,相当于多争取了一次回流的 “寿命”。
3. 优化回流曲线:避免 “过度加热”
将回流峰值温度控制在 235-245℃(而非 260℃),保温时间缩短至 50-60s(而非 80s),能减少锡铜反应速度。测试证实:优化后的回流曲线,可让沉锡板第 3 次回流后的合金层厚度从 4μm 降至 3μm,润湿角保持在 40° 以内(合格)。
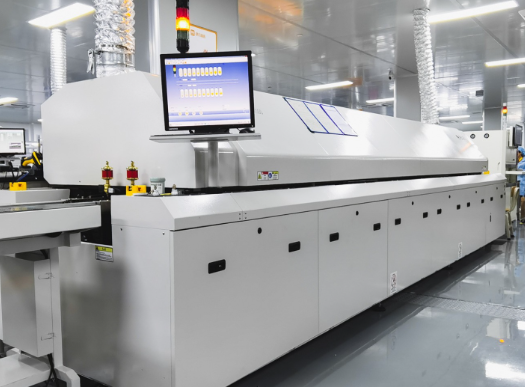
这条看似简单的衰减曲线,实则是沉锡板 “焊接寿命” 的 “晴雨表”—— 读懂它,就能在 SMT 生产中精准把控焊接时机,避免因可焊性衰减导致的批量不良,让每一块沉锡板都能在 “有效期” 内发挥最大价值。






















 991
991

 被折叠的 条评论
为什么被折叠?
被折叠的 条评论
为什么被折叠?








